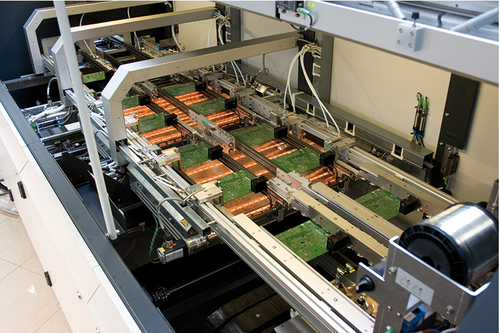
Reflow-svejsning er opdelt i hoveddefekter, sekundære fejl og overfladefejl. Enhver defekt, der deaktiverer funktionen af SMA, kaldes en større defekt; Sekundære defekter henviser til, at fugtbarheden mellem loddesamlinger er god, forårsager ikke tab af SMA-funktion, men har effekten af produktets levetid kan være defekter; Overfladefejl er dem, der ikke påvirker produktets funktion og levetid. Det påvirkes af mange parametre, såsom loddepasta, pasta nøjagtighed og svejseproces. I vores SMT proces forskning og produktion, vi ved, at rimelig overflademonteringsteknologi spiller en afgørende rolle i at kontrollere og forbedre kvaliteten af SMT-produkter.
jeg. Blikperler i reflow lodning
1. Mekanisme for tinperledannelse ved reflow-svejsning: Blikperlen (eller loddekugle) der forekommer ved reflow-svejsning, er ofte skjult mellem siden eller de fint adskilte stifter mellem de to ender af det rektangulære spånelement. I komponentbindingsprocessen, loddepastaen placeres mellem stiften på chipkomponenten og puden. Når den trykte plade passerer gennem reflow-ovnen, loddepastaen smelter til en væske. Hvis de flydende loddepartikler ikke er godt fugtet med puden og apparatstiften, osv., de flydende loddepartikler kan ikke aggregeres til en loddesamling. En del af det flydende loddemiddel vil flyde ud af svejsningen og danne tinperler. Derfor, den dårlige fugtbarhed af loddemetal med puden og apparatstiften er årsagen til dannelsen af tinperler. Loddepasta i printprocessen, på grund af forskydningen mellem stencilen og puden, hvis forskydningen er for stor, det vil få loddepastaen til at flyde uden for puden, og det er nemt at fremstå tinperler efter opvarmning. Z-aksens tryk i monteringsprocessen er en vigtig årsag til tinperler, som man ofte ikke er opmærksom på. Nogle fastgørelsesmaskiner er placeret i henhold til komponentens tykkelse, fordi Z-aksehovedet er placeret i overensstemmelse med komponentens tykkelse, hvilket vil få komponenten til at blive fastgjort til printet og tinknoppen vil blive ekstruderet til ydersiden af svejseskiven. I dette tilfælde, størrelsen af den fremstillede tinperle er lidt større, og produktionen af tinperlen kan normalt forhindres ved blot at genjustere Z-aksens højde.
2. Årsagsanalyse og kontrolmetode: Der er mange årsager til dårlig loddebefugtning, følgende hovedanalyse og relaterede procesrelaterede årsager og løsninger: (1) forkert indstilling af reflukstemperaturkurven. Tilbageløbet af loddepastaen er relateret til temperatur og tid, og hvis tilstrækkelig temperatur eller tid ikke nås, loddepastaen vil ikke tilbagesvale. Temperaturen i forvarmningszonen stiger for hurtigt, og tiden er for kort, så vandet og opløsningsmidlet inde i loddepastaen ikke fordampes fuldstændigt, og når de når tilbageløbstemperaturzonen, vandet og opløsningsmidlet koger tinperlerne ud. Praksis har vist, at det er ideelt at styre temperaturstigningshastigheden i forvarmningszonen kl 1 ~ 4℃/S. (2) Hvis tinperler altid vises i samme position, det er nødvendigt at kontrollere metalskabelonens designstruktur. Korrosionsnøjagtigheden af skabelonåbningsstørrelsen kan ikke opfylde kravene, pudens størrelse er for stor, og overfladematerialet er blødt (såsom kobberskabelon), hvilket vil medføre, at det ydre omrids af den trykte loddepasta bliver uklart og forbundet med hinanden, som for det meste forekommer i tamponprint af fin-pitch-enheder, og vil uundgåeligt forårsage et stort antal tinperler mellem stifterne efter reflow. Derfor, passende skabelonmaterialer og skabelonfremstillingsproces bør vælges i henhold til de forskellige former og centerafstande af pudegrafik for at sikre udskriftskvaliteten af loddepasta. (3) Hvis tiden fra patch til reflow-lodning er for lang, oxidationen af loddepartiklerne i loddepastaen vil få loddepastaen til ikke at flyde tilbage og producere tinperler. Valg af loddepasta med længere levetid (generelt mindst 4H) vil afbøde denne effekt. (4) Desuden, den loddepasta, der er trykt forkert, er ikke renset tilstrækkeligt, hvilket vil få loddepastaen til at forblive på overfladen af printpladen og gennem luften. Deformer den trykte loddepasta, når komponenterne fastgøres, før reflowlodning. Disse er også årsagerne til tinperler. Derfor, det bør fremskynde operatørernes og teknikernes ansvar i produktionsprocessen, strengt overholde proceskravene og driftsprocedurerne for produktion, og styrke kvalitetskontrollen af processen.
to Den ene ende af spånelementet er svejset til puden, og den anden ende vippes op. Dette fænomen kaldes Manhattan-fænomenet. Hovedårsagen til dette fænomen er, at de to ender af komponenten ikke opvarmes jævnt, og loddepastaen smeltes successivt. Ujævn opvarmning i begge ender af komponenten vil blive forårsaget under følgende omstændigheder:
(1) Komponentarrangementsretningen er ikke konstrueret korrekt. Vi forestiller os, at der er en tilbagestrømningsgrænselinje på tværs af bredden af tilbagestrømningsovnen, som vil smelte, så snart loddepastaen passerer igennem den. Den ene ende af det rektangulære spånelement passerer først gennem tilbagestrømningsgrænselinjen, og loddepastaen smelter først, og metaloverfladen af enden af spånelementet har væskeoverfladespænding. Den anden ende når ikke væskefasetemperaturen på 183 °C, loddepastaen er ikke smeltet, og kun bindingskraften af fluxen er langt mindre end overfladespændingen af reflow-loddepastaen, så enden af det usmeltede grundstof står oprejst. Derfor, begge ender af komponenten skal holdes for at komme ind i tilbagestrømningsgrænselinjen på samme tid, så loddepastaen på de to ender af puden smeltes på samme tid, danner en afbalanceret væskeoverfladespænding, og holder komponentens position uændret.
(2) Utilstrækkelig forvarmning af trykte kredsløbskomponenter under gasfasesvejsning. Gasfasen er brugen af inert væskedampkondensering på komponentstiften og PCB-puden, slip varme og smelt loddepastaen. Gasfasesvejsningen er opdelt i balancezonen og dampzonen, og svejsetemperaturen i den mættede dampzone er så høj som 217 °C. I produktionsprocessen, vi fandt, at hvis svejsekomponenten ikke er tilstrækkeligt forvarmet, og temperaturændringen ovenfor 100 °C, forgasningskraften af gasfasesvejsningen er let at flyde spånkomponenten af pakkestørrelsen på mindre end 1206, resulterer i fænomenet vertikale ark. Ved at forvarme den svejste komponent i en høj- og lavtemperaturboks kl 145 ~ 150 ℃ i ca 1 ~ 2 min, og endelig langsomt ind i området med mættet damp til svejsning, fænomenet med arkstående blev elimineret.
(3) Effekten af paddesignkvalitet. Hvis et par pudestørrelse af chipelementet er anderledes eller asymmetrisk, det vil også forårsage, at mængden af trykt loddepasta er inkonsekvent, den lille pude reagerer hurtigt på temperaturen, og loddepastaen på den er nem at smelte, den store pude er det modsatte, så når loddepastaen på den lille pude er smeltet, komponenten rettes ud under påvirkning af overfladespændingen af loddepastaen. Bredden eller mellemrummet på puden er for stor, og arkstående fænomen kan også forekomme. Designet af puden i nøje overensstemmelse med standardspecifikationen er forudsætningen for at løse defekten.
Tre. Bridging Bridging er også en af de almindelige defekter i SMT-produktion, som kan forårsage kortslutninger mellem komponenter og skal repareres, når broen stødes på.
(1) Loddepastaens kvalitetsproblem er, at metalindholdet i loddepastaen er højt, især efter at udskrivningstiden er for lang, metalindholdet er let at øge; Viskositeten af loddepastaen er lav, og det flyder ud af puden efter forvarmning. Dårlig nedgang af loddepasta, efter forvarmning til ydersiden af puden, vil føre til IC pin bridge.
(2) Udskrivningssystemets trykpresse har dårlig gentagelsesnøjagtighed, ujævn justering, og loddepasta-udskrivning til kobberplatin, som mest ses i fin-pitch QFP-produktion; Stålpladejusteringen er ikke god, og PCB-justeringen er ikke god, og stålpladevinduets størrelse/tykkelsesdesign er ikke ensartet med PCB-pudedesignets legeringsbelægning, resulterer i en stor mængde loddepasta, hvilket vil forårsage binding. Løsningen er at justere trykpressen og forbedre PCB-pudebelægningslaget.
(3) Klæbetrykket er for stort, og iblødsætning af loddepastaen efter tryk er en almindelig årsag i produktionen, og Z-aksens højde skal justeres. Hvis nøjagtigheden af plasteret ikke er nok, komponenten forskydes, og IC-stiften er deformeret, det bør forbedres af grunden. (4) Forvarmningshastigheden er for høj, og opløsningsmidlet i loddepastaen er for sent til at fordampe.
Core-pulling-fænomenet, også kendt som core-pulling fænomenet, er en af de almindelige svejsefejl, hvilket er mere almindeligt ved dampfase reflow svejsning. Det centrale sugefænomen er, at loddemetal er adskilt fra puden langs stiften og chiplegemet, hvilket vil danne et seriøst virtuelt svejsefænomen. Årsagen anses normalt for at være den originale stifts store varmeledningsevne, den hurtige temperaturstigning, således at loddet foretrækkes til at fugte stiften, befugtningskraften mellem loddemetal og stiften er meget større end befugtningskraften mellem loddemetal og puden, og opkrævningen af stiften vil forværre forekomsten af kernesugningsfænomenet. Ved infrarød reflow svejsning, PCB-substrat og loddemiddel i den organiske flux er et fremragende infrarødt absorptionsmedium, og stiften kan delvist reflektere infrarødt, derimod, loddet smeltes fortrinsvis, dens befugtningskraft med puden er større end befugtningen mellem den og stiften, så loddet vil stige langs stiften, sandsynligheden for kernesugningsfænomen er meget mindre. Løsningen er: i dampfase reflow svejsning, SMA'en skal først forvarmes helt og derefter sættes i dampfaseovnen; Svejsbarheden af PCB-puden skal kontrolleres omhyggeligt og garanteres, og PCB med dårlig svejsbarhed bør ikke påføres og produceres; Komponenternes koplanaritet kan ikke ignoreres, og enheder med dårlig koplanaritet bør ikke bruges i produktionen.
Fem. Efter svejsning, der vil være lysegrønne bobler omkring de enkelte loddesamlinger, og i alvorlige tilfælde, der vil være en boble på størrelse med et søm, hvilket ikke kun påvirker udseendets kvalitet, men påvirker også præstationen i alvorlige tilfælde, hvilket er et af de problemer, der ofte opstår i svejseprocessen. Grundårsagen til svejsemodstandsfilmens skumdannelse er tilstedeværelsen af gas/vanddamp mellem svejsemodstandsfilmen og det positive substrat. Spormængder af gas/vanddamp føres til forskellige processer, og når der opstår høje temperaturer, gasudvidelse fører til delaminering af loddemodstandsfilmen og det positive substrat. Under svejsning, temperaturen på puden er relativt høj, så boblerne først dukker op omkring puden. Nu skal forarbejdningsprocessen ofte renses, tør og lav derefter den næste proces, såsom efter ætsning, skal tørres og derefter klæbe loddemodstandsfilmen, på dette tidspunkt vil, hvis tørretemperaturen ikke er nok, føre vanddamp ind i den næste proces. PCB-lagringsmiljøet er ikke godt før behandling, luftfugtigheden er for høj, og svejsningen er ikke tørret i tide; I bølgelodningsprocessen, bruger ofte en vandholdig fluxmodstand, hvis PCB-forvarmningstemperaturen ikke er nok, vanddampen i fluxen kommer ind i indersiden af PCB-substratet langs hulvæggen i det gennemgående hul, og vanddampen omkring puden vil først komme ind, og disse situationer vil producere bobler efter støder på høj svejsetemperatur.
Løsningen er: (1) alle aspekter bør kontrolleres nøje, det købte PCB skal inspiceres efter opbevaring, normalt under normale omstændigheder, der burde ikke være noget boblefænomen.
(2) PCB skal opbevares i et ventileret og tørt miljø, opbevaringsperioden er ikke mere end 6 måneder; (3) PCB skal forbages i ovnen før svejsning 105℃/4H ~ 6H;
