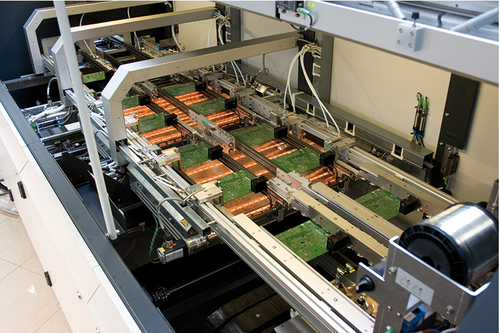
Pengelasan reflow dibagi menjadi cacat utama, cacat sekunder dan cacat permukaan. Setiap cacat yang menonaktifkan fungsi SMA disebut cacat besar; Cacat sekunder mengacu pada keterbasahan antar sambungan solder yang baik, tidak menyebabkan hilangnya fungsi SMA, tetapi memiliki efek pada umur produk mungkin cacat; Cacat permukaan adalah cacat yang tidak mempengaruhi fungsi dan umur produk. Hal ini dipengaruhi oleh banyak parameter, seperti pasta solder, akurasi pasta dan proses pengelasan. Dalam penelitian dan produksi proses SMT kami, kita tahu bahwa teknologi perakitan permukaan yang wajar memainkan peran penting dalam mengendalikan dan meningkatkan kualitas produk SMT.
SAYA. Manik-manik timah dalam penyolderan reflow
1. Mekanisme pembentukan manik timah pada pengelasan reflow: Manik timah (atau bola solder) yang muncul dalam pengelasan reflow sering kali tersembunyi di antara sisi atau pin dengan jarak halus di antara kedua ujung elemen chip persegi panjang. Dalam proses pengikatan komponen, pasta solder ditempatkan di antara pin komponen chip dan bantalan. Saat papan cetak melewati tungku reflow, pasta solder meleleh menjadi cairan. Jika partikel solder cair tidak dibasahi dengan baik dengan bantalan dan pin perangkat, dll., partikel solder cair tidak dapat dikumpulkan menjadi sambungan solder. Sebagian cairan solder akan mengalir keluar dari lasan dan membentuk butiran timah. Karena itu, keterbasahan solder yang buruk dengan bantalan dan pin perangkat adalah penyebab utama terbentuknya butiran timah. Pasta solder dalam proses pencetakan, karena offset antara stensil dan bantalan, jika offset terlalu besar, itu akan menyebabkan pasta solder mengalir keluar bantalan, dan manik-manik timah mudah muncul setelah dipanaskan. Tekanan sumbu Z dalam proses pemasangan merupakan alasan penting untuk manik-manik timah, yang seringkali tidak diperhatikan. Beberapa mesin attachment diposisikan sesuai dengan ketebalan komponen karena kepala sumbu Z terletak sesuai dengan ketebalan komponen., yang akan menyebabkan komponen menempel pada PCB dan tunas timah akan terekstrusi ke luar cakram las. Dalam hal ini, ukuran manik timah yang dihasilkan sedikit lebih besar, dan produksi manik timah biasanya dapat dicegah hanya dengan mengatur ulang ketinggian sumbu Z.
2. Metode analisis dan pengendalian penyebab: Ada banyak alasan mengapa keterbasahan solder buruk, berikut analisa utama dan proses terkait penyebab dan solusinya: (1) pengaturan kurva suhu refluks yang tidak tepat. Refluks pasta solder berhubungan dengan suhu dan waktu, dan jika suhu atau waktu yang memadai tidak tercapai, pasta solder tidak akan mengalami refluks. Suhu di zona pemanasan awal naik terlalu cepat dan waktunya terlalu singkat, agar air dan pelarut di dalam pasta solder tidak menguap seluruhnya, dan ketika mereka mencapai zona suhu reflow, air dan pelarut merebus butiran timah. Praktek telah membuktikan bahwa yang ideal adalah mengontrol laju kenaikan suhu di zona pemanasan awal pada 1 ~ 4℃/Dtk. (2) Jika manik-manik timah selalu muncul pada posisi yang sama, perlu untuk memeriksa struktur desain templat logam. Keakuratan korosi pada ukuran bukaan templat tidak dapat memenuhi persyaratan, ukuran bantalannya terlalu besar, dan bahan permukaannya lembut (seperti templat tembaga), yang akan menyebabkan garis luar pasta solder yang dicetak menjadi tidak jelas dan terhubung satu sama lain, yang sebagian besar terjadi pada pencetakan pad perangkat nada halus, dan pasti akan menyebabkan sejumlah besar manik-manik timah di antara pin setelah dialirkan kembali. Karena itu, bahan templat yang sesuai dan proses pembuatan templat harus dipilih sesuai dengan berbagai bentuk dan jarak tengah grafik pad untuk memastikan kualitas pencetakan pasta solder. (3) Jika waktu dari patch hingga penyolderan reflow terlalu lama, Oksidasi partikel solder pada pasta solder akan menyebabkan pasta solder tidak mengalir kembali dan menghasilkan butiran timah. Memilih pasta solder dengan masa kerja lebih lama (umumnya setidaknya 4 jam) akan mengurangi dampak ini. (4) Selain itu, papan cetak yang salah cetak dengan pasta solder tidak cukup dibersihkan, yang akan menyebabkan pasta solder tetap berada di permukaan papan cetak dan melayang di udara. Deformasi pasta solder yang dicetak saat memasang komponen sebelum penyolderan ulang. Ini juga penyebab manik-manik timah. Karena itu, hal ini harus mempercepat tanggung jawab operator dan teknisi dalam proses produksi, secara ketat mematuhi persyaratan proses dan prosedur operasi untuk produksi, dan memperkuat kontrol kualitas proses.
duaSalah satu ujung elemen chip dilas ke bantalan, dan ujung lainnya dimiringkan ke atas. Fenomena ini disebut fenomena Manhattan. Alasan utama terjadinya fenomena ini adalah kedua ujung komponen tidak memanas secara merata, dan pasta solder dicairkan secara berurutan. Pemanasan yang tidak merata pada kedua ujung komponen akan disebabkan oleh keadaan berikut:
(1) Arah susunan komponen tidak dirancang dengan benar. Kita bayangkan ada garis batas reflow di sepanjang lebar tungku reflow, yang akan meleleh segera setelah pasta solder melewatinya. Salah satu ujung elemen persegi panjang chip melewati garis batas reflow terlebih dahulu, dan pasta soldernya meleleh terlebih dahulu, dan permukaan logam ujung elemen chip mempunyai tegangan permukaan cair. Ujung lainnya tidak mencapai suhu fase cair 183 °C, pasta soldernya tidak meleleh, dan hanya kekuatan ikatan fluks yang jauh lebih kecil daripada tegangan permukaan pasta solder reflow, sehingga ujung elemen yang tidak dicairkan tegak. Karena itu, kedua ujung komponen harus dijaga agar memasuki garis batas reflow pada saat yang bersamaan, agar pasta solder pada kedua ujung bantalan meleleh secara bersamaan, membentuk tegangan permukaan cairan yang seimbang, dan menjaga posisi komponen tidak berubah.
(2) Pemanasan awal komponen sirkuit cetak yang tidak memadai selama pengelasan fase gas. Fase gas adalah penggunaan kondensasi uap cair inert pada pin komponen dan bantalan PCB, lepaskan panas dan lelehkan pasta solder. Pengelasan fasa gas dibagi menjadi zona keseimbangan dan zona uap, dan suhu pengelasan di zona uap jenuh setinggi 217 °C. Dalam proses produksi, kami menemukan bahwa jika komponen pengelasan tidak cukup dipanaskan, dan perubahan suhu di atas 100 °C, kekuatan gasifikasi pengelasan fase gas mudah untuk mengapung komponen chip dengan ukuran paket kurang dari 1206, mengakibatkan fenomena lembaran vertikal. Dengan memanaskan terlebih dahulu komponen yang dilas dalam kotak bersuhu tinggi dan rendah pada 145 ~ 150℃ untuk sekitar 1 ~ 2 menit, dan akhirnya perlahan memasuki area uap jenuh untuk pengelasan, fenomena sheet standing dihilangkan.
(3) Dampak kualitas desain pad. Jika sepasang pad ukuran elemen chip berbeda atau asimetris, itu juga akan menyebabkan jumlah pasta solder yang dicetak tidak konsisten, bantalan kecil merespons suhu dengan cepat, dan pasta solder di atasnya mudah meleleh, pad besar adalah kebalikannya, jadi ketika pasta solder pada bantalan kecil meleleh, komponen diluruskan di bawah pengaruh tegangan permukaan pasta solder. Lebar atau celah pad terlalu besar, dan fenomena sheet standing juga dapat terjadi. Desain bantalan yang sesuai dengan spesifikasi standar merupakan prasyarat untuk mengatasi cacat.
Tiga. Bridging Bridging juga merupakan salah satu cacat umum dalam produksi SMT, yang dapat menyebabkan korsleting antar komponen dan harus diperbaiki bila ditemui jembatan.
(1) Masalah kualitas pasta solder adalah kandungan logam dalam pasta soldernya tinggi, terutama setelah waktu pencetakan terlalu lama, kandungan logamnya mudah meningkat; Viskositas pasta solder rendah, dan mengalir keluar dari bantalan setelah pemanasan awal. Kemerosotan pasta solder yang buruk, setelah pemanasan awal pada bagian luar pad, akan mengarah ke jembatan pin IC.
(2) Mesin cetak sistem pencetakan memiliki akurasi pengulangan yang buruk, kesejajaran yang tidak merata, dan pencetakan pasta solder ke platinum tembaga, yang sebagian besar terlihat dalam produksi QFP nada halus; Penjajaran pelat baja tidak baik dan penjajaran PCB tidak baik dan desain ukuran/ketebalan jendela pelat baja tidak seragam dengan lapisan paduan desain bantalan PCB, menghasilkan pasta solder dalam jumlah besar, yang akan menimbulkan ikatan. Solusinya adalah dengan menyesuaikan mesin cetak dan memperbaiki lapisan pelapis bantalan PCB.
(3) Tekanan lengketnya terlalu besar, dan perendaman pasta solder setelah tekanan adalah alasan umum dalam produksi, dan ketinggian sumbu Z harus disesuaikan. Jika akurasi patch saja tidak cukup, komponennya bergeser dan pin IC berubah bentuk, itu harus ditingkatkan karena alasannya. (4) Kecepatan pemanasan awal terlalu cepat, dan pelarut dalam pasta solder terlambat menguap.
Fenomena penarik inti, juga dikenal sebagai fenomena penarik inti, adalah salah satu cacat pengelasan yang umum, yang lebih umum dalam pengelasan reflow fase uap. Fenomena pengisapan inti adalah solder terpisah dari bantalan di sepanjang pin dan badan chip, yang akan membentuk fenomena pengelasan virtual yang serius. Alasannya biasanya dianggap karena konduktivitas termal yang besar dari pin asli, kenaikan suhu yang cepat, agar solder diutamakan membasahi pin, gaya pembasahan antara solder dan pin jauh lebih besar daripada gaya pembasahan antara solder dan bantalan, dan ke atas pin akan memperparah terjadinya fenomena penghisapan inti. Dalam pengelasan reflow inframerah, Substrat PCB dan solder dalam fluks organik adalah media penyerapan inframerah yang sangat baik, dan pin sebagian dapat memantulkan inframerah, sebaliknya, soldernya lebih disukai meleleh, kekuatan pembasahannya dengan bantalan lebih besar daripada pembasahan antara bantalan dan pin, sehingga solder akan naik sepanjang pin, kemungkinan fenomena penghisapan inti jauh lebih kecil. Solusinya adalah: dalam pengelasan reflow fase uap, SMA harus dipanaskan terlebih dahulu terlebih dahulu dan kemudian dimasukkan ke dalam tungku fase uap; Kemampuan las bantalan PCB harus diperiksa dan dijamin dengan cermat, dan PCB dengan kemampuan las yang buruk tidak boleh diterapkan dan diproduksi; Koplanaritas komponen tidak dapat diabaikan, dan perangkat dengan koplanaritas yang buruk tidak boleh digunakan dalam produksi.
Lima. Setelah pengelasan, akan ada gelembung hijau muda di sekitar sambungan solder individu, dan dalam kasus yang serius, akan ada gelembung sebesar paku, Yang tidak hanya mempengaruhi kualitas penampilan, tetapi juga mempengaruhi kinerja dalam kasus yang serius, yang merupakan salah satu permasalahan yang sering terjadi pada proses pengelasan. Akar penyebab berbusanya film tahan las adalah adanya gas/uap air antara film tahan las dan substrat positif. Sejumlah kecil gas/uap air dibawa ke berbagai proses, dan ketika suhu tinggi ditemui, ekspansi gas menyebabkan delaminasi film resistansi solder dan substrat positif. Selama pengelasan, suhu pad relatif tinggi, jadi gelembung pertama kali muncul di sekitar pad. Sekarang proses pengolahannya seringkali perlu dibersihkan, keringkan lalu lakukan proses selanjutnya, seperti setelah etsa, harus dikeringkan dan kemudian menempelkan film tahan solder, pada saat ini jika suhu pengeringan tidak cukup akan membawa uap air ke proses selanjutnya. Lingkungan penyimpanan PCB tidak baik sebelum diproses, kelembapannya terlalu tinggi, dan pengelasan tidak kering tepat waktu; Dalam proses penyolderan gelombang, sering menggunakan ketahanan fluks yang mengandung air, jika suhu pemanasan awal PCB tidak cukup, uap air dalam fluks akan masuk ke bagian dalam substrat PCB di sepanjang dinding lubang lubang tembus, dan uap air di sekitar pad akan masuk terlebih dahulu, dan situasi ini akan menghasilkan gelembung setelah mengalami suhu pengelasan yang tinggi.
Solusinya adalah: (1) semua aspek harus dikontrol dengan ketat, PCB yang dibeli harus diperiksa setelah penyimpanan, biasanya dalam keadaan standar, seharusnya tidak ada fenomena gelembung.
(2) PCB harus disimpan di lingkungan yang berventilasi dan kering, masa penyimpanan tidak lebih dari 6 bulan; (3) PCB harus dipanggang terlebih dahulu dalam oven sebelum pengelasan 105℃/4H ~ 6H;
