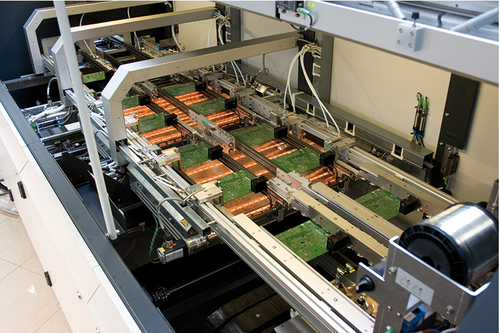
리플로우 용접은 주요 불량으로 구분됩니다., 2차 결함 및 표면 결함. SMA의 기능을 비활성화하는 모든 결함을 주요 결함이라고 합니다.; 2차 결함은 솔더 조인트 사이의 젖음성이 좋다는 것을 의미합니다., SMA 기능의 손실을 초래하지 않습니다., 그러나 제품 수명에 영향을 미치므로 결함이 있을 수 있습니다.; 표면 결함은 제품의 기능 및 수명에 영향을 미치지 않는 결함입니다.. 많은 매개변수의 영향을 받습니다., 솔더 페이스트와 같은, 페이스트 정확도 및 용접 공정. 당사의 SMT 공정 연구 및 생산에서, 우리는 합리적인 표면 조립 기술이 SMT 제품의 품질을 제어하고 개선하는 데 중요한 역할을 한다는 것을 알고 있습니다..
나. 리플로우 솔더링의 주석 비드
1. 리플로우 용접에서 주석 비드 형성 메커니즘: 주석 구슬 (아니면 솔더볼) 리플로우 용접에서 나타나는 결함은 직사각형 칩 요소의 두 끝 사이에 있는 측면 또는 미세한 간격의 핀 사이에 숨겨져 있는 경우가 많습니다.. 부품 접합 공정에서, 솔더 페이스트는 칩 부품의 핀과 패드 사이에 배치됩니다.. 인쇄 기판이 리플로우로를 통과하면서, 솔더 페이스트가 액체로 녹습니다.. 액체 솔더 입자가 패드와 장치 핀에 잘 젖지 않는 경우, 등., 액체 납땜 입자는 납땜 접합부로 응집될 수 없습니다.. 액체 땜납의 일부가 용접부 밖으로 흘러 나와 주석 비드를 형성합니다.. 그러므로, 패드 및 장치 핀과 솔더의 젖음성이 좋지 않아 주석 비드가 형성되는 근본 원인입니다.. 인쇄 공정의 솔더 페이스트, 스텐실과 패드 사이의 오프셋으로 인해, 오프셋이 너무 큰 경우, 솔더 페이스트가 패드 외부로 흐르게 됩니다., 가열 후 주석 구슬이 나타나기 쉽습니다.. 장착 공정에서 Z축의 압력은 주석 비드가 발생하는 중요한 이유입니다., 흔히 주의를 기울이지 않는 것. 일부 부착 기계는 부품의 두께에 따라 Z축 헤드가 위치하기 때문에 부품의 두께에 따라 위치가 결정됩니다., 부품이 PCB에 부착되고 주석 새싹이 용접 디스크 외부로 압출됩니다.. 이 경우, 생산된 주석 비드의 크기가 약간 더 큽니다., 일반적으로 Z축 높이를 재조정하면 주석 비드의 생성을 방지할 수 있습니다..
2. 원인분석 및 제어방법: 열악한 납땜 젖음성에는 여러 가지 이유가 있습니다., 다음과 같은 주요 분석 및 관련 프로세스 관련 원인과 해결 방법: (1) 부적절한 환류 온도 곡선 설정. 솔더 페이스트의 역류는 온도 및 시간과 관련이 있습니다., 충분한 온도나 시간에 도달하지 못한 경우, 솔더 페이스트는 역류하지 않습니다. 예열 구역의 온도가 너무 빨리 올라가고 시간이 너무 짧습니다., 솔더 페이스트 내부의 물과 용매가 완전히 휘발되지 않도록, 그리고 리플로우 온도대에 도달하면, 물과 용매가 주석 구슬을 끓입니다.. 실습을 통해 예열 구역의 온도 상승률을 제어하는 것이 이상적이라는 것이 입증되었습니다. 1 ~4℃/초. (2) 주석 구슬이 항상 같은 위치에 나타나는 경우, 금속 템플릿 디자인 구조를 확인하는 것이 필요합니다. 템플릿 개구부 크기의 부식 정확도가 요구 사항을 충족할 수 없습니다., 패드 크기가 너무 크다, 그리고 표면 재질이 부드러워요 (구리 템플릿과 같은), 인쇄된 솔더 페이스트의 외부 윤곽이 불분명하고 서로 연결되는 원인이 됩니다., 미세 피치 장치의 패드 인쇄에서 주로 발생합니다., 리플로우 후 핀 사이에 필연적으로 많은 수의 주석 비드가 발생하게 됩니다.. 그러므로, 솔더 페이스트의 인쇄 품질을 보장하려면 패드 그래픽의 다양한 모양과 중심 거리에 따라 적합한 템플릿 재료와 템플릿 제작 공정을 선택해야 합니다.. (3) 패치부터 리플로우 솔더링까지의 시간이 너무 긴 경우, 솔더 페이스트에 있는 솔더 입자의 산화로 인해 솔더 페이스트가 리플로우되지 않고 주석 비드가 생성됩니다.. 작동 수명이 더 긴 솔더 페이스트 선택 (일반적으로 적어도 4H) 이 효과를 완화할 것입니다. (4) 게다가, 솔더 페이스트 잘못 인쇄된 인쇄 기판이 충분히 청소되지 않았습니다., 이로 인해 솔더 페이스트가 인쇄 기판 표면과 공기 중에 남게 됩니다.. 리플로우 솔더링 전에 부품을 부착할 때 인쇄된 솔더 페이스트를 변형시킵니다.. 주석구슬이 생기는 원인이기도 합니다. 그러므로, 생산 과정에서 운영자와 기술자의 책임을 가속화해야 합니다., 생산 공정 요구 사항 및 운영 절차를 엄격히 준수합니다., 프로세스의 품질 관리를 강화합니다..
두 개의 칩 요소의 한쪽 끝이 패드에 용접됩니다., 그리고 반대쪽 끝은 위로 기울어져 있어요. 이런 현상을 맨해튼 현상이라고 합니다.. 이 현상의 주된 이유는 부품의 양쪽 끝이 고르게 가열되지 않기 때문입니다., 그리고 솔더 페이스트는 연속적으로 녹습니다.. 다음과 같은 경우 부품 양쪽 끝의 가열이 고르지 않게 발생합니다.:
(1) 부품 배열 방향이 올바르게 설계되지 않았습니다.. 리플로우로의 폭을 가로질러 리플로우 한계선이 있다고 가정합니다., 솔더 페이스트가 통과하자마자 녹을 것입니다.. 칩 직사각형 요소의 한쪽 끝이 리플로우 한계선을 먼저 통과합니다., 그리고 솔더 페이스트가 먼저 녹습니다, 칩 요소 끝의 금속 표면에는 액체 표면 장력이 있습니다.. 다른 쪽 끝은 액상 온도에 도달하지 않습니다. 183 ℃, 솔더 페이스트가 녹지 않습니다, 플럭스의 결합력만이 리플로우 솔더 페이스트의 표면 장력보다 훨씬 작습니다., 녹지 않은 요소의 끝이 수직이 되도록. 그러므로, 리플로우 한계선에 동시에 들어가려면 부품의 양쪽 끝이 유지되어야 합니다., 패드 양끝의 솔더 페이스트가 동시에 녹도록, 균형 잡힌 액체 표면 장력 형성, 구성 요소의 위치를 변경하지 않고 유지합니다..
(2) 가스상 용접 중 인쇄 회로 부품의 예열 부족. 기체상은 부품 핀과 PCB 패드에 불활성 액체 증기 응축을 사용합니다., 열을 방출하고 솔더 페이스트를 녹입니다.. 기상용접은 밸런스존과 스팀존으로 구분됩니다., 포화 증기 구역의 용접 온도는 다음과 같습니다. 217 ℃. 생산 과정에서, 우리는 용접 부품이 충분히 예열되지 않은 경우, 그리고 위의 온도 변화 100 ℃, 가스상 용접의 가스화력은 패키지 크기가 작은 칩 구성 요소를 쉽게 띄울 수 있습니다. 1206, 세로 시트 현상 발생. 고온 및 저온 상자에서 용접 부품을 예열함으로써 145 ~ 150℃ 정도 1 ~ 2분, 마지막으로 용접을 위해 포화 증기 영역으로 천천히 진입합니다., 시트 스탠딩 현상이 제거되었습니다..
(3) 패드 디자인 품질의 영향. 칩 소자의 한 쌍의 패드 크기가 다르거나 비대칭인 경우, 또한 인쇄된 솔더 페이스트의 양이 일정하지 않게 됩니다., 작은 패드는 온도에 빠르게 반응합니다., 그리고 그 위에 있는 솔더 페이스트는 녹기 쉽습니다., 큰 패드는 반대입니다, 그래서 작은 패드의 솔더 페이스트가 녹을 때, 부품은 솔더 페이스트의 표면 장력 작용으로 곧게 펴집니다.. 패드의 폭이나 간격이 너무 넓습니다., 시트가 서는 현상이 발생할 수도 있습니다.. 표준 사양을 엄격하게 준수하는 패드 설계는 결함을 해결하기 위한 전제 조건입니다..
세. 브리징 브리징은 SMT 생산에서 흔히 발생하는 결함 중 하나입니다., 이는 구성 요소 사이에 단락을 일으킬 수 있으며 브리지가 발견되면 수리해야 합니다..
(1) 솔더 페이스트 품질 문제는 솔더 페이스트의 금속 함량이 높다는 것입니다., 특히 인쇄 시간이 너무 길어지면, 금속 함량이 증가하기 쉽습니다.; 솔더 페이스트의 점도가 낮습니다., 예열 후 패드 밖으로 흘러나오는 현상. 솔더 페이스트의 슬럼프 불량, 패드 외부까지 예열 후, IC 핀 브리지로 연결됩니다.
(2) 인쇄 시스템 인쇄기의 반복 정확도가 낮습니다., 고르지 못한 정렬, 구리 백금에 솔더 페이스트 인쇄, 파인피치 QFP 생산에서 주로 볼 수 있는 현상; PCB 패드 디자인 합금코팅으로 철판 정렬 불량 및 PCB 정렬 불량 및 철판 창 크기/두께 설계가 균일하지 않음, 그 결과 다량의 솔더 페이스트가 발생합니다., 결속을 유발할 것입니다.. 해결책은 인쇄기를 조정하고 PCB 패드 코팅층을 개선하는 것입니다..
(3) 접착압력이 너무 크다, 압력을 가한 후 솔더 페이스트를 담그는 것이 생산 과정에서 일반적인 이유입니다., Z축 높이를 조정해야 합니다.. 패치의 정확성이 충분하지 않은 경우, 부품이 이동하고 IC 핀이 변형되었습니다., 개선되어야 할 이유는. (4) 예열 속도가 너무 빠르다, 솔더 페이스트의 용매가 휘발하기에는 너무 늦었습니다..
코어 당김 현상, 코어 당김 현상이라고도 함, 일반적인 용접 결함 중 하나입니다., 이는 증기상 리플로우 용접에서 더 일반적입니다.. 코어 흡입 현상은 핀과 칩 본체를 따라 솔더가 패드에서 분리되는 현상입니다., 이는 심각한 가상 용접 현상을 형성합니다.. 그 이유는 일반적으로 원래 핀의 열전도율이 크기 때문으로 간주됩니다., 급격한 온도 상승, 땜납이 핀을 적시는 것이 바람직하도록, 솔더와 핀 사이의 습윤력은 솔더와 패드 사이의 습윤력보다 훨씬 큽니다., 핀이 위로 휘어지면 코어 흡입 현상이 악화됩니다.. 적외선 리플로우 용접에서, 유기 플럭스의 PCB 기판 및 솔더는 탁월한 적외선 흡수 매체입니다., 핀은 부분적으로 적외선을 반사할 수 있습니다., 대조적으로, 땜납이 우선적으로 녹습니다., 패드와의 습윤력은 패드와 핀 사이의 습윤력보다 큽니다., 그러면 땜납이 핀을 따라 올라갈 것입니다., 코어 흡입 현상이 발생할 확률은 훨씬 작습니다.. 해결책은: 증기상 리플로우 용접에서, SMA는 먼저 완전히 예열된 다음 증기상 퍼니스에 넣어야 합니다.; PCB 패드의 용접성은 주의깊게 점검되고 보장되어야 합니다., 용접성이 나쁜 PCB를 적용, 생산해서는 안 됩니다.; 구성요소의 동일 평면성은 무시할 수 없습니다., 동일 평면성이 낮은 장치는 생산에 사용해서는 안 됩니다..
다섯. 용접 후, 개별 솔더 조인트 주위에 연한 녹색 거품이 나타납니다., 그리고 심각한 경우에는, 손톱 크기의 거품이 생길 것입니다, 외관 품질에 영향을 미칠 뿐만 아니라, 심각한 경우에는 성능에도 영향을 미칩니다, 이는 용접공정에서 흔히 발생하는 문제 중 하나입니다.. 내용착성 필름 발포의 근본 원인은 내용착성 필름과 포지티브 기판 사이에 가스/수증기가 존재하기 때문입니다.. 미량의 가스/수증기가 다른 공정으로 운반됩니다., 그리고 고온에 직면했을 때, 가스 팽창으로 인해 솔더 저항 필름과 포지티브 기판이 분리됩니다.. 용접 중, 패드의 온도가 상대적으로 높습니다., 그래서 거품이 패드 주위에 먼저 나타납니다. 이제 처리 과정을 정리해야 하는 경우가 많습니다., 건조 후 다음 공정 진행, 에칭 후와 같은, 건조시킨 후 솔더 저항 필름을 붙여야 합니다., 이때 건조 온도가 충분하지 않으면 수증기를 다음 공정으로 운반합니다.. 가공 전 PCB 보관 환경이 좋지 않습니다., 습도가 너무 높아, 용접이 제 시간에 건조되지 않았습니다.; 웨이브 솔더링 공정에서, 종종 수분 함유 플럭스 저항을 사용합니다., PCB 예열 온도가 충분하지 않은 경우, 플럭스의 수증기는 관통 구멍의 구멍 벽을 따라 PCB 기판 내부로 들어갑니다., 패드 주변의 수증기가 먼저 들어갑니다., 이러한 상황에서는 용접 온도가 높아지면 기포가 생성됩니다..
해결책은: (1) 모든 면을 엄격히 통제해야 한다, 구매한 PCB는 보관 후 검사를 받아야 합니다., 일반적으로 표준 상황에서, 버블현상이 없을 것.
(2) PCB는 통풍이 잘되고 건조한 환경에 보관해야 합니다., 보관 기간은 다음을 초과하지 않습니다. 6 개월; (3) PCB는 105℃/4H ~ 6H 용접 전 오븐에서 미리 구워야 합니다.;
