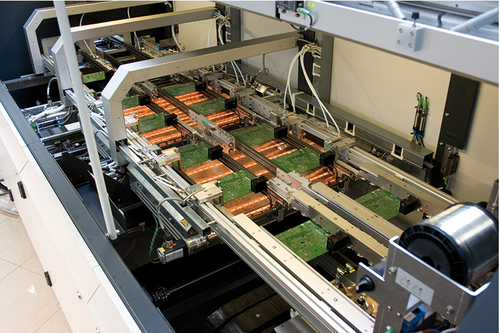
Kimpalan reflow dibahagikan kepada kecacatan utama, kecacatan sekunder dan kecacatan permukaan. Sebarang kecacatan yang melumpuhkan fungsi SMA dipanggil kecacatan besar; Kecacatan sekunder merujuk kepada kebolehbankan antara sendi pateri adalah baik, tidak menyebabkan kehilangan fungsi SMA, tetapi mempunyai kesan kehidupan produk mungkin kecacatan; Kecacatan permukaan adalah yang tidak menjejaskan fungsi dan kehidupan produk. Ia dipengaruhi oleh banyak parameter, seperti pes solder, Tampal ketepatan dan proses kimpalan. Dalam penyelidikan dan pengeluaran proses SMT kami, Kami tahu bahawa teknologi pemasangan permukaan yang munasabah memainkan peranan penting dalam mengawal dan meningkatkan kualiti produk SMT.
I. Manik timah dalam pematerian reflow
1. Mekanisme pembentukan manik timah dalam kimpalan reflow: Manik timah (atau bola solder) yang muncul dalam kimpalan reflow sering tersembunyi di antara sisi atau pin yang halus di antara kedua-dua hujung unsur cip segi empat tepat. Dalam proses ikatan komponen, Paste solder diletakkan di antara pin komponen cip dan pad. Apabila papan bercetak melalui relau reflow, Paste pateri cair ke dalam cecair. Sekiranya zarah solder cecair tidak dibasahi dengan pad dan pin peranti, dll., zarah solder cecair tidak boleh diagregatkan menjadi sendi pateri. Sebahagian daripada solder cecair akan mengalir keluar dari kimpalan dan bentuk manik timah. Oleh itu, Kebolehbaburan solder yang lemah dengan pad dan pin peranti adalah punca utama pembentukan manik timah. Tampal solder dalam proses percetakan, kerana mengimbangi antara stensil dan pad, Sekiranya mengimbangi terlalu besar, ia akan menyebabkan pes pateri mengalir di luar pad, dan mudah muncul manik timah selepas pemanasan. Tekanan paksi z dalam proses pemasangan adalah sebab penting bagi manik timah, yang sering tidak memberi perhatian kepada. Beberapa mesin melampirkan diposisikan mengikut ketebalan komponen kerana kepala paksi z terletak mengikut ketebalan komponen, yang akan menyebabkan komponen dilampirkan pada PCB dan tunas timah akan diekstrusi ke luar cakera kimpalan. Dalam kes ini, Saiz manik timah yang dihasilkan sedikit lebih besar, dan pengeluaran manik timah biasanya boleh dicegah dengan hanya menyesuaikan semula ketinggian z-paksi.
2. Menyebabkan kaedah analisis dan kawalan: Terdapat banyak sebab untuk kebolehbaburan solder yang lemah, Analisis utama dan penyebab dan penyelesaian yang berkaitan dengan proses yang berkaitan: (1) Tetapan lengkung suhu refluks yang tidak betul. Refluks pes pateri berkaitan dengan suhu dan masa, dan jika suhu atau masa yang mencukupi tidak dapat dicapai, pes solder tidak akan refluks. Suhu di zon pemanasan meningkat terlalu cepat dan masa terlalu pendek, supaya air dan pelarut di dalam pasta solder tidak sepenuhnya volatilasi, dan ketika mereka mencapai zon suhu reflow, air dan pelarut mendidih manik timah. Amalan telah membuktikan bahawa ia adalah sesuai untuk mengawal kadar kenaikan suhu di zon pemanasan di 1 ~ 4 ℃/s. (2) Sekiranya manik timah selalu muncul dalam kedudukan yang sama, adalah perlu untuk memeriksa struktur reka bentuk templat logam. Ketepatan kakisan saiz pembukaan templat tidak dapat memenuhi syarat, saiz pad terlalu besar, dan bahan permukaannya lembut (seperti templat tembaga), yang akan menyebabkan garis luaran pasta solder bercetak tidak jelas dan bersambung antara satu sama lain, yang kebanyakannya berlaku dalam percetakan pad peranti halus, dan tidak dapat dielakkan menyebabkan sebilangan besar manik timah di antara pin selepas reflow. Oleh itu, Bahan templat yang sesuai dan proses membuat templat harus dipilih mengikut bentuk yang berbeza dan jarak pusat grafik pad untuk memastikan kualiti percetakan pasta solder. (3) Sekiranya masa dari patch untuk reflow pematerian terlalu lama, Pengoksidaan zarah solder dalam pes pateri akan menyebabkan pes pateri tidak mencerminkan dan menghasilkan manik timah. Memilih pes solder dengan kehidupan kerja yang lebih lama (Umumnya sekurang -kurangnya 4 jam) akan mengurangkan kesan ini. (4) Di samping itu, Papan cetak yang tidak dicetak solder tidak cukup dibersihkan, yang akan menyebabkan pes pateri kekal di permukaan papan bercetak dan melalui udara. Ubah bentuk tampal solder bercetak semasa melampirkan komponen sebelum pematerian reflow. Ini juga merupakan punca manik timah. Oleh itu, Ia harus mempercepatkan tanggungjawab pengendali dan juruteknik dalam proses pengeluaran, tegas mematuhi keperluan proses dan prosedur operasi untuk pengeluaran, dan mengukuhkan kawalan kualiti proses.
Dua hujung unsur cip dikimpal ke pad, dan ujung yang lain condong. Fenomena ini dipanggil fenomena Manhattan. Sebab utama fenomena ini adalah bahawa kedua -dua hujung komponen tidak dipanaskan secara merata, Dan pes pateri dicairkan secara berturut -turut. Pemanasan yang tidak rata di kedua -dua hujung komponen akan disebabkan dalam keadaan berikut:
(1) Arah susunan komponen tidak direka dengan betul. Kami membayangkan bahawa terdapat garis had reflow merentasi lebar relau reflow, yang akan mencairkan sebaik sahaja pes pateri melaluinya. Satu hujung elemen segi empat tepat cip melewati garis had reflow terlebih dahulu, dan pes pateri mencairkan terlebih dahulu, dan permukaan logam akhir elemen cip mempunyai ketegangan permukaan cecair. Hujung yang lain tidak mencapai suhu fasa cecair 183 ° C., pes pateri tidak cair, dan hanya daya ikatan fluks jauh lebih rendah daripada ketegangan permukaan pes solder reflow, supaya akhir elemen yang tidak terkawal tegak. Oleh itu, Kedua -dua hujung komponen harus disimpan untuk memasuki garis had reflow pada masa yang sama, supaya tampalan pateri di kedua -dua hujung pad cair pada masa yang sama, membentuk ketegangan permukaan cecair yang seimbang, dan menjaga kedudukan komponen tidak berubah.
(2) Tidak mencukupi pemanasan komponen litar bercetak semasa kimpalan fasa gas. Fasa gas adalah penggunaan pemeluwapan wap cecair lengai pada pin komponen dan pad pcb, melepaskan haba dan cairkan pasta solder. Kimpalan fasa gas dibahagikan kepada zon keseimbangan dan zon stim, dan suhu kimpalan di zon stim tepu setinggi 217 ° C.. Dalam proses pengeluaran, Kami mendapati bahawa jika komponen kimpalan tidak cukup dipanaskan, dan perubahan suhu di atas 100 ° C., Daya gasifikasi kimpalan fasa gas mudah untuk mengapungkan komponen cip saiz pakej kurang dari 1206, mengakibatkan fenomena lembaran menegak. Dengan memanaskan komponen dikimpal dalam kotak suhu tinggi dan rendah di 145 ~ 150 ℃ untuk kira -kira 1 ~ 2 min, dan akhirnya perlahan memasuki kawasan stim tepu untuk kimpalan, Fenomena pendirian lembaran dihapuskan.
(3) Kesan kualiti reka bentuk pad. Sekiranya sepasang saiz pad elemen cip berbeza atau tidak simetris, it will also cause the amount of printed solder paste is inconsistent, pad kecil bertindak balas dengan cepat ke suhu, dan pes pateri di atasnya mudah dicairkan, pad besar adalah sebaliknya, Oleh itu, apabila tampalan pateri pada pad kecil cair, komponen diluruskan di bawah tindakan ketegangan permukaan pes solder. Lebar atau jurang pad terlalu besar, dan fenomena berdiri lembaran juga mungkin berlaku. Reka bentuk pad mengikut ketat dengan spesifikasi standard adalah prasyarat untuk menyelesaikan kecacatan.
Tiga. Bridging Bridging juga merupakan salah satu kecacatan biasa dalam pengeluaran SMT, yang boleh menyebabkan litar pintas antara komponen dan mesti diperbaiki apabila jambatan ditemui.
(1) Masalah kualiti tampal pateri adalah bahawa kandungan logam dalam tampalan pateri tinggi, terutamanya selepas masa percetakan terlalu lama, Kandungan logam mudah ditingkatkan; Kelikatan pes pateri rendah, Dan ia mengalir keluar dari pad selepas memanaskan. Kemerosotan tampal solder yang lemah, setelah memanaskan badan di luar pad, akan membawa kepada jambatan pin IC.
(2) Akhbar percetakan sistem percetakan mempunyai ketepatan berulang yang lemah, Penjajaran yang tidak sekata, dan percetakan tampal solder ke platinum tembaga, yang kebanyakannya dilihat dalam pengeluaran QFP halus; Penjajaran plat keluli tidak baik dan penjajaran PCB tidak baik dan reka bentuk saiz tingkap/ketebalan plat keluli tidak seragam dengan lapisan aloi reka bentuk pad pcb, mengakibatkan jumlah pes solder yang banyak, yang akan menyebabkan ikatan. Penyelesaiannya adalah untuk menyesuaikan akhbar percetakan dan memperbaiki lapisan salutan pad pcb.
(3) Tekanan melekat terlalu besar, Dan perendaman pes pateri selepas tekanan adalah alasan yang sama dalam pengeluaran, dan ketinggian paksi z harus diselaraskan. Sekiranya ketepatan patch tidak mencukupi, komponennya beralih dan pin IC cacat, ia harus diperbaiki dengan alasannya. (4) Kelajuan pemanasan terlalu cepat, dan pelarut dalam pes pateri sudah terlambat untuk menundukkan.
Fenomena teras, juga dikenali sebagai fenomena teras yang menarik, adalah salah satu kecacatan kimpalan biasa, yang lebih biasa dalam kimpalan reflow fasa wap. Fenomena sedutan teras adalah bahawa pateri dipisahkan dari pad di sepanjang pin dan badan cip, yang akan membentuk fenomena kimpalan maya yang serius. Sebabnya biasanya dianggap sebagai kekonduksian terma besar pin asal, kenaikan suhu pesat, supaya solder lebih disukai untuk membasahi pin, Daya pembasahan antara pateri dan pin jauh lebih besar daripada daya pembasahan antara solder dan pad, dan upwarping pin akan memburukkan lagi kejadian fenomena sedutan teras. Dalam kimpalan reflow inframerah, Substrat PCB dan Solder dalam Fluks Organik adalah medium penyerapan inframerah yang sangat baik, dan pin sebahagiannya boleh mencerminkan inframerah, Sebaliknya, solder lebih disukai cair, Daya pembasahannya dengan pad lebih besar daripada pembasahan di antaranya dan pin, Jadi solder akan bangkit di sepanjang pin, kebarangkalian fenomena sedutan teras jauh lebih kecil. Penyelesaiannya adalah: dalam fasa wap reflow kimpalan, SMA harus dipanaskan sepenuhnya dahulu dan kemudian dimasukkan ke dalam relau fasa wap; Kebolehkesanan pad PCB harus diperiksa dengan teliti dan dijamin, dan PCB dengan kebolehkalasan yang lemah tidak boleh digunakan dan dihasilkan; Komponen komponen tidak dapat diabaikan, dan peranti dengan coplanarity yang lemah tidak boleh digunakan dalam pengeluaran.
Lima. Selepas kimpalan, Akan ada gelembung hijau ringan di sekitar sendi solder individu, dan dalam kes yang serius, akan ada gelembung saiz kuku, yang bukan sahaja mempengaruhi kualiti penampilan, tetapi juga mempengaruhi prestasi dalam kes yang serius, yang merupakan salah satu masalah yang sering berlaku dalam proses kimpalan. Punca akar filem rintangan kimpalan yang berbuih adalah kehadiran wap gas/air antara filem rintangan kimpalan dan substrat positif. Jejak jumlah gas/wap air dibawa ke proses yang berbeza, dan apabila suhu tinggi ditemui, Pengembangan gas membawa kepada penyingkiran filem rintangan solder dan substrat positif. Semasa kimpalan, suhu pad agak tinggi, Jadi gelembung pertama muncul di sekitar pad. Sekarang proses pemprosesan sering perlu dibersihkan, kering dan kemudian lakukan proses seterusnya, seperti selepas etsa, harus dikeringkan dan kemudian melekatkan filem rintangan solder, Pada masa ini jika suhu pengeringan tidak mencukupi akan membawa wap air ke dalam proses seterusnya. Persekitaran penyimpanan PCB tidak baik sebelum diproses, kelembapan terlalu tinggi, dan kimpalan tidak dikeringkan dalam masa; Dalam proses pematerian gelombang, sering menggunakan rintangan fluks yang mengandungi air, Sekiranya suhu pemanasan PCB tidak mencukupi, Wap air di fluks akan memasuki bahagian dalam substrat PCB di sepanjang dinding lubang melalui lubang, Dan wap air di sekeliling pad akan masuk terlebih dahulu, dan situasi ini akan menghasilkan gelembung setelah menghadapi suhu kimpalan yang tinggi.
Penyelesaiannya adalah: (1) Semua aspek harus dikawal dengan ketat, PCB yang dibeli harus diperiksa selepas penyimpanan, biasanya dalam keadaan standard, Tidak ada fenomena gelembung.
(2) PCB harus disimpan dalam persekitaran yang berventilasi dan kering, Tempoh penyimpanan tidak lebih daripada 6 bulan; (3) PCB sepatutnya dibakar di dalam ketuhar sebelum kimpalan 105 ℃/4H ~ 6H;
