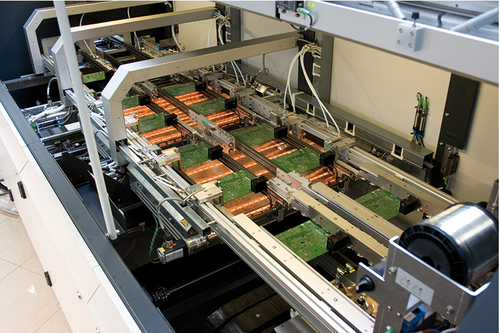
Reflow-lassen is onderverdeeld in hoofddefecten, secundaire defecten en oppervlaktedefecten. Elk defect dat de functie van SMA uitschakelt, wordt een groot defect genoemd; Secundaire defecten verwijzen naar de goede bevochtigbaarheid tussen soldeerverbindingen, veroorzaakt geen verlies van de SMA-functie, maar heeft het effect van de levensduur van het product kunnen defecten zijn; Oppervlaktedefecten zijn defecten die de werking en levensduur van het product niet beïnvloeden. Het wordt beïnvloed door veel parameters, zoals soldeerpasta, pastanauwkeurigheid en lasproces. In ons SMT-procesonderzoek en productie, we weten dat redelijke oppervlakteassemblagetechnologie een cruciale rol speelt bij het controleren en verbeteren van de kwaliteit van SMT-producten.
I. Tinparels bij reflow-solderen
1. Mechanisme van tinparelvorming bij reflow-lassen: De tinnen kraal (of soldeerbal) dat bij reflow-lassen verschijnt, is vaak verborgen tussen de zijkant of de pennen met kleine tussenruimte tussen de twee uiteinden van het rechthoekige chipelement. In het componentverbindingsproces, de soldeerpasta wordt tussen de pin van de chipcomponent en de pad geplaatst. Terwijl de printplaat door de reflow-oven gaat, de soldeerpasta smelt tot een vloeistof. Als de vloeibare soldeerdeeltjes niet goed worden bevochtigd met de pad en de apparaatpin, enz., de vloeibare soldeerdeeltjes kunnen niet tot een soldeerverbinding worden samengevoegd. Een deel van het vloeibare soldeer zal uit de las vloeien en tinparels vormen. Daarom, de slechte bevochtigbaarheid van het soldeer met het kussentje en de pin van het apparaat is de hoofdoorzaak van de vorming van tinparels. Soldeerpasta tijdens het printproces, vanwege de offset tussen het stencil en de pad, als de offset te groot is, hierdoor zal de soldeerpasta buiten de pad vloeien, en het is gemakkelijk om tinnen kralen te laten verschijnen na verwarming. De druk van de Z-as tijdens het montageproces is een belangrijke reden voor tinnen kralen, waar vaak geen aandacht aan wordt besteed. Sommige bevestigingsmachines worden gepositioneerd op basis van de dikte van het onderdeel, omdat de Z-askop zich bevindt op basis van de dikte van het onderdeel, waardoor het onderdeel aan de PCB wordt bevestigd en de tinknop naar de buitenkant van de lasschijf wordt geëxtrudeerd. In dit geval, de maat van de geproduceerde tinnen kraal is iets groter, en de productie van de tinnen kraal kan meestal worden voorkomen door eenvoudigweg de hoogte van de Z-as opnieuw aan te passen.
2. Oorzaakanalyse en controlemethode: Er zijn veel redenen voor een slechte soldeerbevochtigbaarheid, de volgende hoofdanalyse en gerelateerde procesgerelateerde oorzaken en oplossingen: (1) onjuiste instelling van de refluxtemperatuurcurve. De reflux van de soldeerpasta is gerelateerd aan temperatuur en tijd, en als er niet voldoende temperatuur of tijd wordt bereikt, de soldeerpasta zal niet terugvloeien. De temperatuur in de voorverwarmzone stijgt te snel en de tijd is te kort, zodat het water en oplosmiddel in de soldeerpasta niet volledig vervluchtigd zijn, en wanneer ze de reflow-temperatuurzone bereiken, het water en het oplosmiddel koken de tinnen kralen uit. De praktijk heeft uitgewezen dat het ideaal is om de temperatuurstijging in de voorverwarmingszone te beheersen 1 ~ 4℃/S. (2) Als tinnen kralen verschijnen altijd in dezelfde positie, het is noodzakelijk om de ontwerpstructuur van de metalen sjabloon te controleren. De corrosienauwkeurigheid van de openingsgrootte van de sjabloon kan niet aan de vereisten voldoen, de maat van de pad is te groot, en het oppervlaktemateriaal is zacht (zoals kopersjabloon), waardoor de externe omtrek van de gedrukte soldeerpasta onduidelijk zal zijn en met elkaar verbonden zal zijn, wat vooral voorkomt bij het tampondrukken van apparaten met een fijne spoed, en zal na het terugvloeien onvermijdelijk een groot aantal tinnen kralen tussen de pinnen veroorzaken. Daarom, geschikte sjabloonmaterialen en het sjabloonmaakproces moeten worden geselecteerd op basis van de verschillende vormen en hartafstanden van padafbeeldingen om de afdrukkwaliteit van soldeerpasta te garanderen. (3) Als de tijd tussen patch en reflow-solderen te lang is, de oxidatie van de soldeerdeeltjes in de soldeerpasta zorgt ervoor dat de soldeerpasta niet terugstroomt en tinparels produceert. Kiezen voor een soldeerpasta met een langere levensduur (doorgaans minimaal 4 uur) zal dit effect verzachten. (4) In aanvulling, de soldeerpasta verkeerd bedrukte printplaat is niet voldoende gereinigd, waardoor de soldeerpasta op het oppervlak van de printplaat en door de lucht blijft. Vervorm de gedrukte soldeerpasta bij het bevestigen van componenten vóór het reflow-solderen. Dit zijn ook de oorzaken van tinnen kralen. Daarom, het zou de verantwoordelijkheid van operators en technici in het productieproces moeten versnellen, Voldoe strikt aan de procesvereisten en operationele procedures voor productie, en de kwaliteitscontrole van het proces versterken.
twee Het ene uiteinde van het chipelement is aan het kussen gelast, en het andere uiteinde is omhoog gekanteld. Dit fenomeen wordt het Manhattan-fenomeen genoemd. De belangrijkste reden voor dit fenomeen is dat de twee uiteinden van het onderdeel niet gelijkmatig worden verwarmd, en de soldeerpasta wordt achtereenvolgens gesmolten. Onder de volgende omstandigheden kan een ongelijkmatige verwarming aan beide uiteinden van het onderdeel worden veroorzaakt:
(1) De plaatsingsrichting van de componenten is niet correct ontworpen. We stellen ons voor dat er een reflow-limietlijn loopt over de breedte van de reflow-oven, die smelt zodra de soldeerpasta er doorheen gaat. Eén uiteinde van het rechthoekige chipelement gaat als eerste door de terugstroomlimietlijn, en de soldeerpasta smelt eerst, en het metalen oppervlak van het uiteinde van het chipelement heeft een vloeibare oppervlaktespanning. Het andere uiteinde bereikt de vloeistoffasetemperatuur niet 183 ° C, de soldeerpasta is niet gesmolten, en alleen de hechtkracht van het vloeimiddel is veel minder dan de oppervlaktespanning van de reflow-soldeerpasta, zodat het uiteinde van het niet-gesmolten element rechtop staat. Daarom, beide uiteinden van de component moeten zo worden gehouden dat ze tegelijkertijd de reflowlimietlijn binnengaan, zodat de soldeerpasta aan de twee uiteinden van het kussen tegelijkertijd wordt gesmolten, het vormen van een evenwichtige vloeistofoppervlaktespanning, en het ongewijzigd houden van de positie van het onderdeel.
(2) Onvoldoende voorverwarmen van printplaatcomponenten tijdens gasfaselassen. De gasfase is het gebruik van inerte vloeistofdampcondensatie op de componentpin en het PCB-pad, laat warmte vrij en smelt de soldeerpasta. Het gasfaselassen is verdeeld in de balanszone en de stoomzone, en de lastemperatuur in de verzadigde stoomzone is zo hoog als 217 ° C. Bij het productieproces, we ontdekten dat als het lasonderdeel niet voldoende wordt voorverwarmd, en de temperatuurverandering hierboven 100 ° C, de vergassingskracht van het gasfaselassen is gemakkelijk om de chipcomponent van de verpakkingsgrootte van minder dan te drijven 1206, resulterend in het verticale plaatfenomeen. Door het gelaste onderdeel voor te verwarmen in een hoge- en lagetemperatuurkast bij 145 ~ 150℃ voor ongeveer 1 ~ 2 minuten, en tenslotte langzaam het verzadigde stoomgebied binnengaan om te lassen, het fenomeen van het staan van de plaat werd geëlimineerd.
(3) De impact van de kwaliteit van het padontwerp. Als een paar kussenafmetingen van het chipelement anders of asymmetrisch is, het zal er ook voor zorgen dat de hoeveelheid afgedrukte soldeerpasta inconsistent is, de kleine pad reageert snel op de temperatuur, en de soldeerpasta erop smelt gemakkelijk, het grote kussen is het tegenovergestelde, dus wanneer de soldeerpasta op het kleine kussentje is gesmolten, het onderdeel wordt rechtgetrokken onder invloed van de oppervlaktespanning van de soldeerpasta. De breedte of opening van het kussen is te groot, en het fenomeen van het staan van de plaat kan ook optreden. Het ontwerp van de pad in strikte overeenstemming met de standaardspecificatie is een voorwaarde om het defect op te lossen.
Drie. Overbruggen Overbruggen is ook een van de meest voorkomende tekortkomingen bij de SMT-productie, die kortsluitingen tussen componenten kunnen veroorzaken en moeten worden gerepareerd wanneer de brug wordt aangetroffen.
(1) Het kwaliteitsprobleem van de soldeerpasta is dat het metaalgehalte in de soldeerpasta hoog is, vooral nadat de afdruktijd te lang is, het metaalgehalte is eenvoudig te verhogen; De viscositeit van de soldeerpasta is laag, en het stroomt na het voorverwarmen uit de pad. Slechte inzinking van soldeerpasta, na voorverwarmen aan de buitenkant van de pad, zal leiden tot een IC-pinbrug.
(2) De drukpers van het afdruksysteem heeft een slechte herhalingsnauwkeurigheid, ongelijke uitlijning, en printen met soldeerpasta op koperplatina, wat vooral te zien is bij QFP-productie met fijne toonhoogte; De uitlijning van de stalen plaat is niet goed en de uitlijning van de PCB is niet goed en het ontwerp van de venstergrootte/dikte van de stalen plaat is niet uniform met de legeringscoating van het PCB-padontwerp, resulterend in een grote hoeveelheid soldeerpasta, wat voor binding zal zorgen. De oplossing is om de drukpers aan te passen en de PCB-padcoatinglaag te verbeteren.
(3) De kleefdruk is te groot, en het weken van de soldeerpasta na druk is een veel voorkomende reden bij de productie, en de hoogte van de Z-as moet worden aangepast. Als de nauwkeurigheid van de patch niet genoeg is, het onderdeel is verschoven en de IC-pin is vervormd, het moet om de reden worden verbeterd. (4) De voorverwarmingssnelheid is te snel, en het oplosmiddel in de soldeerpasta is te laat om te vervluchtigen.
Het fenomeen kerntrekken, ook bekend als het kerntrekkende fenomeen, is een van de meest voorkomende lasfouten, wat vaker voorkomt bij dampfase-reflow-lassen. Het kernzuigfenomeen is dat het soldeersel langs de pin en het chiplichaam van het kussen wordt gescheiden, wat een serieus virtueel lasfenomeen zal vormen. De reden wordt meestal beschouwd als de grote thermische geleidbaarheid van de originele pin, de snelle temperatuurstijging, zodat het soldeer de voorkeur heeft om de pin te bevochtigen, de bevochtigingskracht tussen het soldeer en de pin is veel groter dan de bevochtigingskracht tussen het soldeer en het kussentje, en het naar boven kromtrekken van de pen zal het optreden van het kernzuigfenomeen verergeren. Bij infrarood reflow-lassen, PCB-substraat en soldeer in de organische flux zijn een uitstekend infraroodabsorptiemedium, en de pin kan infrarood gedeeltelijk reflecteren, in tegenstelling, het soldeer wordt bij voorkeur gesmolten, de bevochtigingskracht met het kussen is groter dan de bevochtiging tussen het kussen en de pin, zodat het soldeer langs de pin omhoog zal komen, de waarschijnlijkheid van het fenomeen kernzuiging is veel kleiner. De oplossing is: bij het dampfase-reflow-lassen, de SMA moet eerst volledig worden voorverwarmd en vervolgens in de dampfaseoven worden geplaatst; De lasbaarheid van de PCB-pad moet zorgvuldig worden gecontroleerd en gegarandeerd, en PCB's met slechte lasbaarheid mogen niet worden toegepast en geproduceerd; De coplanariteit van componenten kan niet worden genegeerd, en apparaten met een slechte coplanariteit mogen niet in de productie worden gebruikt.
Vijf. Na het lassen, er zullen lichtgroene belletjes rond de individuele soldeerverbindingen verschijnen, en in ernstige gevallen, er zal een bel zijn ter grootte van een spijker, wat niet alleen de uiterlijke kwaliteit beïnvloedt, maar beïnvloedt ook de prestaties in ernstige gevallen, wat een van de problemen is die vaak voorkomen bij het lasproces. De hoofdoorzaak van het schuimen van de lasweerstandsfilm is de aanwezigheid van gas/waterdamp tussen de lasweerstandsfilm en het positieve substraat. Sporenhoeveelheden gas/waterdamp worden naar verschillende processen gevoerd, en wanneer er sprake is van hoge temperaturen, gasexpansie leidt tot delaminatie van de soldeerweerstandsfilm en het positieve substraat. Tijdens het lassen, de temperatuur van de pad is relatief hoog, zodat de belletjes eerst rond het kussen verschijnen. Nu moet het verwerkingsproces vaak worden gereinigd, droog en voer dan het volgende proces uit, zoals na het etsen, moet worden gedroogd en plak vervolgens de soldeerweerstandsfilm, op dit moment, als de droogtemperatuur niet voldoende is, zal waterdamp naar het volgende proces worden gevoerd. De PCB-opslagomgeving is niet goed vóór verwerking, de luchtvochtigheid is te hoog, en het laswerk is niet op tijd gedroogd; In het golfsoldeerproces, maken vaak gebruik van een waterhoudende fluxweerstand, als de voorverwarmingstemperatuur van de printplaat niet voldoende is, de waterdamp in de flux zal de binnenkant van het PCB-substraat binnendringen langs de gatwand van het doorgaande gat, en de waterdamp rond het kussen zal als eerste binnendringen, en deze situaties zullen luchtbellen produceren na het tegenkomen van een hoge lastemperatuur.
De oplossing is: (1) alle aspecten moeten strikt worden gecontroleerd, de gekochte printplaat moet na opslag worden geïnspecteerd, meestal onder standaardomstandigheden, er mag geen bubbelfenomeen zijn.
(2) PCB's moeten worden opgeslagen in een geventileerde en droge omgeving, de bewaartermijn bedraagt niet meer dan 6 maanden; (3) PCB's moeten in de oven worden voorgebakken voordat ze worden gelast op 105 ℃/4H ~ 6H;
