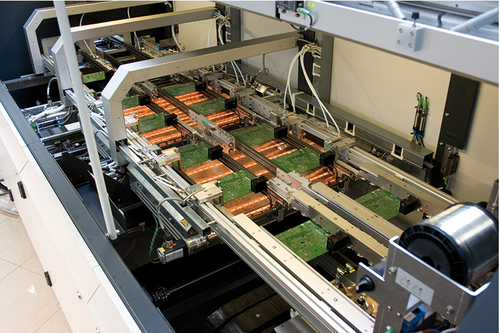
การเชื่อม Reflow แบ่งออกเป็นข้อบกพร่องหลัก, ข้อบกพร่องที่สองและข้อบกพร่องของพื้นผิว. ข้อบกพร่องใด ๆ ที่ทำให้การทำงานของ SMA หยุดชะงักเรียกว่าข้อบกพร่องที่สำคัญ; ข้อบกพร่องรองหมายถึงความสามารถในการเปียกระหว่างข้อต่อบัดกรีได้ดี, ไม่ทำให้สูญเสียฟังก์ชัน SMA, แต่มีผลกระทบต่ออายุการใช้งานสินค้าอาจมีตำหนิได้; ข้อบกพร่องที่พื้นผิวคือข้อบกพร่องที่ไม่ส่งผลกระทบต่อการทำงานและอายุการใช้งานของผลิตภัณฑ์. ได้รับผลกระทบจากพารามิเตอร์หลายตัว, เช่น ผงประสาน, วางความแม่นยำและกระบวนการเชื่อม. ในการวิจัยและการผลิตกระบวนการ SMT ของเรา, เรารู้ว่าเทคโนโลยีการประกอบพื้นผิวที่เหมาะสมมีบทบาทสำคัญในการควบคุมและปรับปรุงคุณภาพของผลิตภัณฑ์ SMT.
ฉัน. เม็ดบีดดีบุกในการบัดกรีแบบรีโฟลว์
1. กลไกการเกิดเม็ดบีดดีบุกในการเชื่อมแบบรีโฟลว์: ลูกปัดดีบุก (หรือลูกประสาน) ที่ปรากฏในการเชื่อมแบบรีโฟลว์มักจะซ่อนอยู่ระหว่างด้านข้างหรือหมุดที่มีระยะห่างระหว่างปลายทั้งสองของชิ้นส่วนชิปสี่เหลี่ยม. ในกระบวนการเชื่อมส่วนประกอบ, วางประสานระหว่างพินของส่วนประกอบชิปและแผ่น. ขณะที่บอร์ดพิมพ์ผ่านเตาหลอมซ้ำ, วางประสานละลายเป็นของเหลว. หากอนุภาคของน้ำยาบัดกรีไม่เปียกกับแผ่นและพินของอุปกรณ์, ฯลฯ, อนุภาคบัดกรีเหลวไม่สามารถรวมเป็นข้อต่อประสานได้. ส่วนหนึ่งของน้ำยาบัดกรีจะไหลออกจากรอยเชื่อมและก่อตัวเป็นเม็ดดีบุก. ดังนั้น, ความสามารถในการเปียกได้ไม่ดีของการบัดกรีด้วยแผ่นอิเล็กโทรดและพินของอุปกรณ์เป็นสาเหตุหลักของการก่อตัวของเม็ดบีดดีบุก. วางประสานในกระบวนการพิมพ์, เนื่องจากการชดเชยระหว่างลายฉลุและแผ่น, ถ้าออฟเซ็ตใหญ่เกินไป, มันจะทำให้สารบัดกรีไหลออกนอกแผ่น, และปรากฏเม็ดบีดดีบุกได้ง่ายหลังจากให้ความร้อน. แรงกดของแกน Z ในกระบวนการติดตั้งเป็นเหตุผลสำคัญสำหรับเม็ดบีดดีบุก, ซึ่งมักไม่ค่อยได้ใส่ใจ. เครื่องติดบางเครื่องมีตำแหน่งตามความหนาของส่วนประกอบ เนื่องจากหัวแกน Z ตั้งอยู่ตามความหนาของส่วนประกอบ, ซึ่งจะทำให้ส่วนประกอบติดเข้ากับ PCB และดีบุกบัดจะถูกอัดออกมาด้านนอกของแผ่นเชื่อม. ในกรณีนี้, ขนาดของลูกปัดดีบุกที่ผลิตจะใหญ่กว่าเล็กน้อย, และโดยทั่วไปสามารถป้องกันการผลิตเม็ดบีดดีบุกได้โดยเพียงแค่ปรับความสูงของแกน Z อีกครั้ง.
2. วิธีวิเคราะห์และควบคุมสาเหตุ: มีสาเหตุหลายประการที่ทำให้การบัดกรีเปียกได้ไม่ดี, การวิเคราะห์หลักต่อไปนี้และสาเหตุและแนวทางแก้ไขที่เกี่ยวข้องกับกระบวนการที่เกี่ยวข้อง: (1) การตั้งค่าเส้นโค้งอุณหภูมิกรดไหลย้อนที่ไม่เหมาะสม. การไหลย้อนของสารบัดกรีนั้นสัมพันธ์กับอุณหภูมิและเวลา, และหากไม่ถึงอุณหภูมิหรือเวลาเพียงพอ, วางประสานจะไม่ไหลย้อน. อุณหภูมิในเขตอุ่นเครื่องเพิ่มขึ้นเร็วเกินไปและเวลาสั้นเกินไป, เพื่อให้น้ำและตัวทำละลายภายในสารบัดกรีไม่ระเหยจนหมด, และเมื่อถึงโซนอุณหภูมิรีโฟลว์, น้ำและตัวทำละลายต้มเม็ดดีบุกออกมา. การปฏิบัติได้พิสูจน์แล้วว่าการควบคุมอัตราการเพิ่มขึ้นของอุณหภูมิในบริเวณอุ่นเครื่องที่เหมาะเป็นอย่างยิ่ง 1 ~ 4℃/เอส. (2) หากเม็ดบีดดีบุกปรากฏอยู่ในตำแหน่งเดิมเสมอ, จำเป็นต้องตรวจสอบโครงสร้างการออกแบบเทมเพลตโลหะ. ความแม่นยำในการกัดกร่อนของขนาดเปิดเทมเพลตไม่สามารถตอบสนองความต้องการได้, ขนาดของแผ่นรองใหญ่เกินไป, และวัสดุพื้นผิวมีความนุ่ม (เช่นแบบทองแดง), ซึ่งจะทำให้โครงร่างภายนอกของแผ่นบัดกรีที่พิมพ์ออกมาไม่ชัดเจนและเชื่อมต่อถึงกัน, ซึ่งส่วนใหญ่เกิดขึ้นในการพิมพ์แพดของอุปกรณ์ที่มีระยะพิทช์ละเอียด, และจะทำให้เกิดเม็ดบีดดีบุกจำนวนมากอย่างหลีกเลี่ยงไม่ได้ระหว่างหมุดหลังจากการรีโฟลว์. ดังนั้น, ควรเลือกวัสดุเทมเพลตและกระบวนการสร้างเทมเพลตที่เหมาะสมตามรูปร่างที่แตกต่างกันและระยะกึ่งกลางของกราฟิกแผ่นเพื่อให้แน่ใจว่าคุณภาพการพิมพ์ของสารบัดกรี. (3) หากเวลาตั้งแต่แพทช์ไปจนถึงการบัดกรีแบบรีโฟลว์นานเกินไป, การเกิดออกซิเดชันของอนุภาคโลหะบัดกรีในสารบัดกรีจะทำให้สารบัดกรีไม่ไหลกลับและผลิตเม็ดดีบุก. การเลือกวางบัดกรีที่มีอายุการใช้งานยาวนานขึ้น (โดยทั่วไปอย่างน้อย 4H) จะบรรเทาผลกระทบนี้ได้. (4) นอกจากนี้, บอร์ดที่พิมพ์ผิดแบบวางประสานไม่ได้รับการทำความสะอาดอย่างเพียงพอ, ซึ่งจะทำให้สารบัดกรียังคงอยู่บนพื้นผิวของแผ่นพิมพ์และผ่านอากาศ. ทำให้สารบัดกรีที่พิมพ์ออกมาผิดรูปเมื่อติดส่วนประกอบก่อนทำการบัดกรีแบบรีโฟลว์. สิ่งเหล่านี้เป็นสาเหตุของเม็ดบีดดีบุก. ดังนั้น, ควรเร่งความรับผิดชอบของผู้ปฏิบัติงานและช่างเทคนิคในกระบวนการผลิต, ปฏิบัติตามข้อกำหนดกระบวนการและขั้นตอนการปฏิบัติงานสำหรับการผลิตอย่างเคร่งครัด, และเสริมสร้างการควบคุมคุณภาพของกระบวนการ.
สองปลายด้านหนึ่งขององค์ประกอบชิปถูกเชื่อมเข้ากับแผ่น, และปลายอีกด้านก็เอียงขึ้น. ปรากฏการณ์นี้เรียกว่าปรากฏการณ์แมนฮัตตัน. สาเหตุหลักของปรากฏการณ์นี้คือปลายทั้งสองข้างของส่วนประกอบไม่ได้รับความร้อนเท่ากัน, และประสานก็ละลายอย่างต่อเนื่อง. ความร้อนที่ไม่สม่ำเสมอที่ปลายทั้งสองด้านของส่วนประกอบจะเกิดขึ้นในสถานการณ์ต่อไปนี้:
(1) ทิศทางการจัดส่วนประกอบไม่ได้รับการออกแบบอย่างถูกต้อง. เราจินตนาการว่ามีเส้นจำกัดการไหลซ้ำพาดผ่านความกว้างของเตาหลอมละลาย, ซึ่งจะละลายทันทีที่สารบัดกรีทะลุผ่าน. ปลายด้านหนึ่งขององค์ประกอบสี่เหลี่ยมชิปจะผ่านเส้นจำกัดการเรียงกลับก่อน, และเนื้อประสานจะละลายก่อน, และพื้นผิวโลหะที่ส่วนปลายของชิ้นส่วนชิปจะมีแรงตึงผิวของของเหลว. ปลายอีกด้านหนึ่งไม่ถึงอุณหภูมิเฟสของเหลวของ 183 ° C, เนื้อบัดกรีไม่ละลาย, และมีเพียงแรงยึดเหนี่ยวของฟลักซ์เท่านั้นที่น้อยกว่าแรงตึงผิวของสารประสานแบบรีโฟลว์มาก, เพื่อให้ส่วนปลายของธาตุที่ยังไม่ละลายตั้งตรง. ดังนั้น, ควรเก็บปลายทั้งสองของส่วนประกอบไว้เพื่อเข้าสู่เส้นจำกัดการไหลในเวลาเดียวกัน, เพื่อให้ประสานที่ปลายทั้งสองของแผ่นละลายในเวลาเดียวกัน, สร้างแรงตึงผิวของของเหลวที่สมดุล, และรักษาตำแหน่งของส่วนประกอบไม่เปลี่ยนแปลง.
(2) การอุ่นส่วนประกอบวงจรพิมพ์ไม่เพียงพอระหว่างการเชื่อมเฟสแก๊ส. เฟสก๊าซคือการใช้การควบแน่นของไอของเหลวเฉื่อยบนพินส่วนประกอบและแผ่น PCB, ปล่อยความร้อนและละลายสารบัดกรี. การเชื่อมเฟสแก๊สแบ่งออกเป็นโซนสมดุลและโซนไอน้ำ, และอุณหภูมิการเชื่อมในโซนไอน้ำอิ่มตัวจะสูงถึง 217 ° C. ในกระบวนการผลิต, เราพบว่าหากส่วนประกอบการเชื่อมไม่ได้รับการอุ่นเพียงพอ, และอุณหภูมิเปลี่ยนแปลงไปด้านบน 100 ° C, แรงแปรสภาพเป็นแก๊สของการเชื่อมเฟสแก๊สเป็นเรื่องง่ายที่จะลอยส่วนประกอบชิปของขนาดบรรจุภัณฑ์ที่น้อยกว่า 1206, ส่งผลให้เกิดปรากฏการณ์แผ่นแนวตั้ง. โดยการอุ่นชิ้นส่วนที่เชื่อมไว้ในกล่องอุณหภูมิสูงและต่ำที่ 145 ~ 150°C ประมาณ 1 ~ 2 นาที, และสุดท้ายก็ค่อย ๆ เข้าสู่บริเวณไอน้ำอิ่มตัวเพื่อทำการเชื่อม, ปรากฏการณ์การยืนแผ่นก็หมดไป.
(3) ผลกระทบของคุณภาพการออกแบบแผ่นอิเล็กโทรด. หากขนาดแผ่นคู่ขององค์ประกอบชิปแตกต่างหรือไม่สมมาตร, นอกจากนี้ยังจะทำให้ปริมาณการบัดกรีที่พิมพ์ออกมาไม่สอดคล้องกันอีกด้วย, แผ่นเล็กตอบสนองต่ออุณหภูมิได้รวดเร็ว, และสารบัดกรีที่ละลายนั้นก็ละลายได้ง่าย, แผ่นใหญ่อยู่ตรงข้าม, ดังนั้นเมื่อตะกั่วบัดกรีบนแผ่นเล็กละลาย, ส่วนประกอบจะถูกยืดให้ตรงภายใต้แรงตึงผิวของสารบัดกรี. ความกว้างหรือช่องว่างของแผ่นมีขนาดใหญ่เกินไป, และปรากฏการณ์การยืนแผ่นก็อาจเกิดขึ้นได้เช่นกัน. การออกแบบแผ่นอิเล็กโทรดตามข้อกำหนดมาตรฐานอย่างเคร่งครัดถือเป็นข้อกำหนดเบื้องต้นในการแก้ไขข้อบกพร่อง.
สาม. การเชื่อมต่อ การเชื่อมต่อเป็นหนึ่งในข้อบกพร่องทั่วไปในการผลิต SMT, ซึ่งอาจทำให้เกิดไฟฟ้าลัดวงจรระหว่างส่วนประกอบต่างๆ ได้ และต้องซ่อมแซมเมื่อเจอสะพาน.
(1) ปัญหาคุณภาพการวางประสานคือปริมาณโลหะในการวางประสานสูง, โดยเฉพาะหลังจากใช้เวลาพิมพ์นานเกินไป, ปริมาณโลหะเพิ่มขึ้นได้ง่าย; ความหนืดของสารบัดกรีอยู่ในระดับต่ำ, และจะไหลออกจากแผ่นหลังจากอุ่นเครื่องแล้ว. การตกต่ำของสารประสานที่ไม่ดี, หลังจากอุ่นไปด้านนอกของแผ่นแล้ว, จะนำไปสู่สะพานไอซีพิน.
(2) แท่นพิมพ์ของระบบการพิมพ์มีความแม่นยำในการทำซ้ำต่ำ, การจัดตำแหน่งที่ไม่สม่ำเสมอ, และการพิมพ์แบบวางประสานไปยังแพลตตินัมทองแดง, ซึ่งส่วนใหญ่พบเห็นได้ในการผลิต QFP ระดับละเอียด; การจัดตำแหน่งแผ่นเหล็กไม่ดี และการจัดตำแหน่ง PCB ไม่ดี และการออกแบบขนาด/ความหนาของแผ่นเหล็กหน้าต่างไม่เหมือนกันกับการเคลือบโลหะผสมการออกแบบแผ่น PCB, ส่งผลให้มีการบัดกรีเป็นจำนวนมาก, ซึ่งจะทำให้เกิดความผูกพัน. วิธีแก้ไขคือการปรับแท่นพิมพ์และปรับปรุงชั้นเคลือบแผ่น PCB.
(3) แรงกดเกาะมีขนาดใหญ่เกินไป, และการแช่ของสารบัดกรีหลังจากแรงดันเป็นสาเหตุทั่วไปในการผลิต, และควรปรับความสูงของแกน Z. หากความถูกต้องของแพทช์ยังไม่เพียงพอ, ส่วนประกอบถูกเลื่อนและขา IC ผิดรูป, มันควรได้รับการปรับปรุงด้วยเหตุผล. (4) ความเร็วในการอุ่นเร็วเกินไป, และตัวทำละลายในสารประสานก็สายเกินไปที่จะระเหย.
ปรากฏการณ์การดึงแกนกลาง, หรือที่เรียกว่าปรากฏการณ์การดึงแกนกลาง, เป็นหนึ่งในข้อบกพร่องในการเชื่อมทั่วไป, ซึ่งพบได้บ่อยในการเชื่อมแบบรีโฟลว์เฟสไอ. ปรากฏการณ์การดูดแกนกลางคือการบัดกรีถูกแยกออกจากแผ่นตามพินและตัวชิป, ซึ่งจะก่อให้เกิดปรากฏการณ์การเชื่อมเสมือนจริงที่ร้ายแรง. สาเหตุมักจะถือว่าเป็นเพราะค่าการนำความร้อนที่สูงของพินดั้งเดิม, อุณหภูมิที่เพิ่มขึ้นอย่างรวดเร็ว, เพื่อให้บัดกรีเป็นที่นิยมในการทำให้หมุดเปียก, แรงเปียกระหว่างบัดกรีและพินนั้นมากกว่าแรงเปียกระหว่างบัดกรีและแผ่น, และการโค้งงอของพินจะทำให้ปรากฏการณ์การดูดแกนรุนแรงขึ้น. ในการเชื่อมแบบรีโฟลว์อินฟราเรด, สารตั้งต้น PCB และสารบัดกรีในฟลักซ์อินทรีย์เป็นสื่อการดูดกลืนแสงอินฟราเรดที่ดีเยี่ยม, และหมุดสามารถสะท้อนอินฟราเรดได้บางส่วน, ในทางตรงกันข้าม, บัดกรีจะละลายเป็นพิเศษ, แรงทำให้เปียกกับแผ่นมีมากกว่าแรงเปียกระหว่างมันกับหมุด, ดังนั้นลวดบัดกรีจะลอยขึ้นมาตามหมุด, ความน่าจะเป็นของปรากฏการณ์การดูดแกนมีน้อยกว่ามาก. วิธีแก้ไขก็คือ: ในการเชื่อมแบบรีโฟลว์เฟสไอ, ควรอุ่น SMA เต็มที่ก่อนแล้วจึงใส่ลงในเตาเฟสไอ; ควรตรวจสอบและรับประกันความสามารถในการเชื่อมของแผ่น PCB อย่างระมัดระวัง, และไม่ควรใช้และผลิต PCB ที่มีความสามารถในการเชื่อมต่ำ; ไม่สามารถละเลย coplanarity ของส่วนประกอบได้, และไม่ควรใช้อุปกรณ์ที่มีระนาบร่วมต่ำในการผลิต.
ห้า. หลังการเชื่อม, จะมีฟองสีเขียวอ่อนรอบๆ ข้อต่อบัดกรีแต่ละอัน, และในกรณีที่ร้ายแรง, จะมีฟองขนาดเท่าเล็บ, ซึ่งไม่เพียงส่งผลต่อคุณภาพรูปลักษณ์เท่านั้น, แต่ยังส่งผลต่อประสิทธิภาพการทำงานในกรณีที่ร้ายแรงด้วย, ซึ่งเป็นหนึ่งในปัญหาที่มักเกิดขึ้นในกระบวนการเชื่อม. สาเหตุหลักของการเกิดฟองของฟิล์มต้านทานการเชื่อมคือการมีก๊าซ/ไอน้ำอยู่ระหว่างฟิล์มต้านทานการเชื่อมกับสารตั้งต้นที่เป็นบวก. ปริมาณก๊าซ/ไอน้ำปริมาณเล็กน้อยถูกส่งไปยังกระบวนการต่างๆ, และเมื่อเจอกับอุณหภูมิสูง, การขยายตัวของก๊าซทำให้เกิดการหลุดล่อนของฟิล์มต้านทานการบัดกรีและสารตั้งต้นที่เป็นบวก. ระหว่างการเชื่อม, อุณหภูมิของแผ่นค่อนข้างสูง, ฟองอากาศจึงปรากฏขึ้นรอบๆ แผ่นก่อน. ตอนนี้กระบวนการแปรรูปมักจะต้องได้รับการทำความสะอาด, แห้งแล้วจึงทำขั้นตอนต่อไป, เช่นหลังจากการแกะสลัก, ควรตากให้แห้งแล้วจึงติดฟิล์มต้านทานการบัดกรี, ในเวลานี้หากอุณหภูมิการอบแห้งไม่เพียงพอจะนำไอน้ำไปสู่กระบวนการต่อไป. สภาพแวดล้อมการจัดเก็บข้อมูล PCB ไม่ดีก่อนการประมวลผล, ความชื้นสูงเกินไป, และการเชื่อมไม่แห้งทันเวลา; ในกระบวนการบัดกรีด้วยคลื่น, มักใช้ความต้านทานฟลักซ์ที่มีน้ำ, หากอุณหภูมิอุ่น PCB ไม่เพียงพอ, ไอน้ำในฟลักซ์จะเข้าสู่ด้านในของสารตั้งต้น PCB ตามผนังรูของรูทะลุ, และไอน้ำรอบๆ แผ่นจะเข้าไปก่อน, และสถานการณ์เหล่านี้จะทำให้เกิดฟองอากาศหลังจากเผชิญกับอุณหภูมิการเชื่อมที่สูง.
วิธีแก้ไขก็คือ: (1) ควรควบคุมทุกด้านอย่างเข้มงวด, ควรตรวจสอบ PCB ที่ซื้อมาหลังการเก็บรักษา, มักจะอยู่ภายใต้สถานการณ์มาตรฐาน, ไม่ควรมีปรากฏการณ์ฟองสบู่เกิดขึ้น.
(2) ควรเก็บ PCB ไว้ในที่ที่มีอากาศถ่ายเทและแห้ง, ระยะเวลาการเก็บรักษาไม่เกิน 6 เดือน; (3) ควรอบ PCB ล่วงหน้าในเตาอบก่อนเชื่อมที่อุณหภูมิ 105°C/4H ~ 6H;
