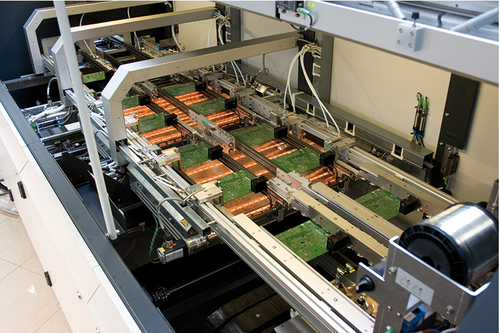
Das Reflow-Schweißen wird in Hauptfehler unterteilt, Sekundärfehler und Oberflächenfehler. Jeder Defekt, der die Funktion von SMA außer Kraft setzt, wird als schwerwiegender Defekt bezeichnet; Sekundäre Mängel beziehen sich darauf, dass die Benetzbarkeit zwischen den Lötstellen gut ist, führt nicht zum Verlust der SMA-Funktion, Aber es kann zu Mängeln kommen, die sich auf die Lebensdauer des Produkts auswirken; Oberflächenfehler sind solche, die die Funktion und Lebensdauer des Produkts nicht beeinträchtigen. Es wird von vielen Parametern beeinflusst, wie zum Beispiel Lotpaste, Pastengenauigkeit und Schweißprozess. In unserer SMT-Prozessforschung und -produktion, Wir wissen, dass eine vernünftige Oberflächenmontagetechnologie eine entscheidende Rolle bei der Kontrolle und Verbesserung der Qualität von SMT-Produkten spielt.
ICH. Zinnperlen beim Reflowlöten
1. Mechanismus der Bildung von Zinnperlen beim Reflow-Schweißen: Die Zinnperle (oder Lötkugel) Das beim Reflow-Schweißen auftretende Material ist häufig zwischen der Seite oder den fein beabstandeten Stiften zwischen den beiden Enden des rechteckigen Chipelements verborgen. Im Bauteilklebeprozess, Die Lotpaste wird zwischen dem Pin des Chipbauteils und dem Pad platziert. Während die Leiterplatte den Reflow-Ofen durchläuft, Die Lotpaste schmilzt zu einer Flüssigkeit. Wenn die flüssigen Lotpartikel das Pad und den Gerätestift nicht gut benetzen, usw., Die flüssigen Lotpartikel können nicht zu einer Lötstelle aggregiert werden. Ein Teil des flüssigen Lotes fließt aus der Schweißnaht und bildet Zinnperlen. daher, Die schlechte Benetzbarkeit des Lotes mit dem Pad und dem Gerätestift ist die Hauptursache für die Bildung von Zinnperlen. Lotpaste im Druckprozess, aufgrund des Versatzes zwischen Schablone und Unterlage, wenn der Offset zu groß ist, Dadurch fließt die Lötpaste aus dem Pad heraus, und es ist leicht, nach dem Erhitzen Zinnperlen zu bilden. Der Druck der Z-Achse beim Montagevorgang ist ein wichtiger Grund für Zinnperlen, was oft nicht beachtet wird. Einige Befestigungsmaschinen werden entsprechend der Dicke des Bauteils positioniert, da der Z-Achsen-Kopf entsprechend der Dicke des Bauteils positioniert ist, Dadurch wird das Bauteil an der Leiterplatte befestigt und die Zinnknospe wird zur Außenseite der Schweißscheibe extrudiert. In diesem Fall, Die Größe der erzeugten Zinnperlen ist etwas größer, und die Bildung des Zinnwulstes kann in der Regel durch eine einfache Neueinstellung der Höhe der Z-Achse verhindert werden.
2. Ursachenanalyse- und Kontrollmethode: Es gibt viele Gründe für eine schlechte Benetzbarkeit des Lotes, Die folgende Hauptanalyse und die damit verbundenen prozessbezogenen Ursachen und Lösungen: (1) Falsche Einstellung der Rückflusstemperaturkurve. Der Rückfluss der Lotpaste hängt von Temperatur und Zeit ab, und wenn keine ausreichende Temperatur oder Zeit erreicht wird, Die Lotpaste wird nicht refluxieren. Die Temperatur in der Vorwärmzone steigt zu schnell und die Zeit ist zu kurz, damit sich das Wasser und das Lösungsmittel in der Lotpaste nicht vollständig verflüchtigen, und wenn sie die Reflow-Temperaturzone erreichen, Das Wasser und das Lösungsmittel kochen die Zinnperlen aus. Die Praxis hat gezeigt, dass es ideal ist, die Temperaturanstiegsgeschwindigkeit in der Vorwärmzone bei zu steuern 1 ~ 4℃/S. (2) Wenn Zinnperlen immer an der gleichen Position erscheinen, Es ist notwendig, die Designstruktur der Metallschablone zu überprüfen. Die Korrosionsgenauigkeit der Schablonenöffnungsgröße kann die Anforderungen nicht erfüllen, Die Größe des Pads ist zu groß, und das Oberflächenmaterial ist weich (wie Kupferschablone), Dies führt dazu, dass die äußeren Umrisse der gedruckten Lotpaste unklar und miteinander verbunden sind, was vor allem beim Tampondruck von Fine-Pitch-Geräten auftritt, und führt nach dem Reflow unweigerlich zu einer großen Anzahl von Zinnperlen zwischen den Stiften. daher, Entsprechend den unterschiedlichen Formen und Achsabständen der Pad-Grafiken sollten geeignete Schablonenmaterialien und Schablonenherstellungsverfahren ausgewählt werden, um die Druckqualität der Lotpaste sicherzustellen. (3) Wenn die Zeit vom Patch bis zum Reflow-Löten zu lang ist, Die Oxidation der Lotpartikel in der Lotpaste führt dazu, dass die Lotpaste nicht auffließt und Zinnperlen entstehen. Wählen Sie eine Lotpaste mit einer längeren Lebensdauer (im Allgemeinen mindestens 4H) wird diesen Effekt abschwächen. (4) Zusätzlich, Die mit Lotpaste bedruckte Leiterplatte ist nicht ausreichend gereinigt, Dies führt dazu, dass die Lötpaste auf der Oberfläche der Leiterplatte und in der Luft verbleibt. Verformen Sie die gedruckte Lotpaste beim Anbringen von Bauteilen vor dem Reflow-Löten. Dies sind auch die Ursachen für Zinnperlen. daher, Es soll die Verantwortung von Bedienern und Technikern im Produktionsprozess beschleunigen, Halten Sie sich strikt an die Prozessanforderungen und Betriebsabläufe für die Produktion, und die Qualitätskontrolle des Prozesses stärken.
zwei Ein Ende des Chipelements ist mit dem Pad verschweißt, und das andere Ende ist nach oben geneigt. Dieses Phänomen wird Manhattan-Phänomen genannt. Der Hauptgrund für dieses Phänomen liegt darin, dass die beiden Enden des Bauteils nicht gleichmäßig erhitzt werden, und die Lotpaste wird nacheinander geschmolzen. Unter den folgenden Umständen kommt es zu einer ungleichmäßigen Erwärmung an beiden Enden der Komponente:
(1) Die Richtung der Komponentenanordnung ist nicht korrekt ausgelegt. Wir stellen uns vor, dass es über die gesamte Breite des Reflow-Ofens eine Reflow-Grenzlinie gibt, die schmilzt, sobald die Lotpaste hindurchtritt. Ein Ende des rechteckigen Chipelements durchläuft zuerst die Reflow-Grenzlinie, und die Lotpaste schmilzt zuerst, und die Metalloberfläche des Endes des Chipelements weist eine Flüssigkeitsoberflächenspannung auf. Das andere Ende erreicht nicht die Temperatur der flüssigen Phase 183 °C, die Lotpaste ist nicht geschmolzen, und nur die Bindungskraft des Flussmittels ist weitaus geringer als die Oberflächenspannung der Reflow-Lötpaste, so dass das Ende des ungeschmolzenen Elements aufrecht steht. daher, Beide Enden des Bauteils sollten so gehalten werden, dass sie gleichzeitig in die Reflow-Grenzlinie gelangen, so dass die Lotpaste an den beiden Enden des Pads gleichzeitig geschmolzen wird, Bildung einer ausgeglichenen Flüssigkeitsoberflächenspannung, und die Position der Komponente unverändert zu lassen.
(2) Unzureichende Vorwärmung der Leiterplattenkomponenten beim Gasphasenschweißen. Die Gasphase ist die Verwendung der Kondensation von inertem Flüssigkeitsdampf auf dem Bauteilstift und dem PCB-Pad, Wärme abgeben und die Lotpaste schmelzen. Das Gasphasenschweißen ist in die Gleichgewichtszone und die Dampfzone unterteilt, und die Schweißtemperatur in der Sattdampfzone beträgt so hoch wie 217 °C. Im Produktionsprozess, Wir haben festgestellt, dass die Schweißkomponente nicht ausreichend vorgewärmt ist, und die Temperaturänderung oben 100 °C, Durch die Vergasungskraft des Gasphasenschweißens lässt sich die Chipkomponente leicht in einer Packungsgröße von weniger als 100 g schweben lassen 1206, Dies führt zum vertikalen Blattphänomen. Durch Vorwärmen des geschweißten Bauteils in einer Hoch- und Tieftemperaturbox 145 ~ 150℃ für ca 1 ~ 2 Min, und schließlich langsames Eintreten in den Sattdampfbereich zum Schweißen, das Phänomen des Blattstehens wurde beseitigt.
(3) Der Einfluss der Qualität des Pad-Designs. Wenn ein Paar Pad-Größen des Chipelements unterschiedlich oder asymmetrisch ist, Dies führt auch dazu, dass die Menge der gedruckten Lotpaste inkonsistent ist, Das kleine Pad reagiert schnell auf die Temperatur, und die darauf befindliche Lötpaste lässt sich leicht schmelzen, Das große Pad ist das Gegenteil, also wenn die Lötpaste auf dem kleinen Pad geschmolzen ist, Unter der Wirkung der Oberflächenspannung der Lotpaste wird das Bauteil begradigt. Die Breite oder der Spalt des Pads ist zu groß, und das Phänomen des Blattstehens kann ebenfalls auftreten. Die Konstruktion des Pads in strikter Übereinstimmung mit der Standardspezifikation ist die Voraussetzung für die Behebung des Mangels.
Drei. Bridging Bridging ist ebenfalls einer der häufigsten Fehler in der SMT-Produktion, Dies kann zu Kurzschlüssen zwischen Komponenten führen und muss beim Auftreten der Brücke repariert werden.
(1) Das Problem der Lotpastenqualität besteht darin, dass der Metallgehalt in der Lotpaste hoch ist, vor allem, wenn die Druckzeit zu lang ist, Der Metallgehalt lässt sich leicht erhöhen; Die Viskosität der Lotpaste ist gering, und es fließt nach dem Vorheizen aus dem Pad. Schlechtes Abfließen der Lotpaste, nach dem Vorwärmen an die Außenseite des Pads, führt zur IC-Pin-Brücke.
(2) Die Druckmaschine des Drucksystems weist eine schlechte Wiederholgenauigkeit auf, ungleichmäßige Ausrichtung, und Lotpastendruck auf Kupfer-Platin, was vor allem bei der Produktion von Fine-Pitch-QFPs der Fall ist; Die Ausrichtung der Stahlplatte ist nicht gut und die Ausrichtung der Leiterplatte ist nicht gut, und die Größe/Dicke des Stahlplattenfensters stimmt nicht mit der Legierungsbeschichtung des PCB-Pad-Designs überein, Dadurch entsteht eine große Menge Lotpaste, was zu einer Verklebung führt. Die Lösung besteht darin, die Druckmaschine anzupassen und die Beschichtungsschicht des PCB-Pads zu verbessern.
(3) Der Klebedruck ist zu groß, und das Durchnässen der Lotpaste nach dem Druck ist ein häufiger Grund in der Produktion, und die Höhe der Z-Achse sollte angepasst werden. Wenn die Genauigkeit des Patches nicht ausreicht, Das Bauteil wird verschoben und der IC-Pin verformt, Aus diesem Grund sollte es verbessert werden. (4) Die Vorheizgeschwindigkeit ist zu hoch, und das Lösungsmittel in der Lotpaste verflüchtigt sich zu spät.
Das Phänomen des Kernziehens, auch als Kernzieh-Phänomen bekannt, ist einer der häufigsten Schweißfehler, was beim Dampfphasen-Reflow-Schweißen häufiger vorkommt. Das Kernsaugphänomen besteht darin, dass das Lot entlang des Stifts und des Chipkörpers vom Pad getrennt wird, Dies wird ein ernstes virtuelles Schweißphänomen darstellen. Als Grund wird üblicherweise die große Wärmeleitfähigkeit des Originalstifts angesehen, der schnelle Temperaturanstieg, so dass das Lot vorzugsweise den Stift benetzt, Die Benetzungskraft zwischen Lot und Stift ist viel größer als die Benetzungskraft zwischen Lot und Pad, und die Aufwärtskrümmung des Stifts wird das Auftreten des Kernsaugphänomens verschlimmern. Beim Infrarot-Reflow-Schweißen, PCB-Substrat und Lot im organischen Flussmittel sind ein ausgezeichnetes Infrarot-Absorptionsmedium, und der Stift kann Infrarot teilweise reflektieren, im Gegensatz, das Lot wird vorzugsweise geschmolzen, seine Benetzungskraft mit dem Pad ist größer als die Benetzung zwischen ihm und dem Stift, so dass das Lot entlang des Stifts aufsteigt, Die Wahrscheinlichkeit eines Kernsogphänomens ist viel geringer. Die Lösung ist: beim Dampfphasen-Reflow-Schweißen, Die SMA sollte zunächst vollständig vorgewärmt und dann in den Dampfphasenofen gegeben werden; Die Schweißbarkeit des PCB-Pads sollte sorgfältig geprüft und gewährleistet werden, und Leiterplatten mit schlechter Schweißbarkeit sollten nicht angewendet und hergestellt werden; Die Koplanarität der Komponenten kann nicht ignoriert werden, und Geräte mit schlechter Koplanarität sollten in der Produktion nicht verwendet werden.
Fünf. Nach dem Schweißen, Um die einzelnen Lötstellen bilden sich hellgrüne Blasen, und in schwerwiegenden Fällen, Es entsteht eine Blase von der Größe eines Nagels, was sich nicht nur auf die optische Qualität auswirkt, beeinträchtigt aber in schwerwiegenden Fällen auch die Leistung, Dies ist eines der Probleme, die beim Schweißprozess häufig auftreten. Die Hauptursache für das Aufschäumen des Schweißwiderstandsfilms ist das Vorhandensein von Gas/Wasserdampf zwischen dem Schweißwiderstandsfilm und dem positiven Substrat. Spurenmengen an Gas/Wasserdampf werden zu verschiedenen Prozessen transportiert, und wenn hohe Temperaturen auftreten, Die Gasausdehnung führt zur Delaminierung des Lötwiderstandsfilms und des positiven Substrats. Beim Schweißen, die Temperatur des Pads ist relativ hoch, Daher erscheinen die Blasen zuerst um das Pad herum. Nun muss der Verarbeitungsprozess häufig gereinigt werden, trocknen und dann den nächsten Vorgang durchführen, beispielsweise nach dem Ätzen, sollte getrocknet werden und dann den Lötwiderstandsfilm aufkleben, Wenn zu diesem Zeitpunkt die Trocknungstemperatur nicht ausreicht, wird Wasserdampf in den nächsten Prozess transportiert. Die PCB-Lagerumgebung ist vor der Verarbeitung nicht gut, die Luftfeuchtigkeit ist zu hoch, und die Schweißnaht trocknet nicht rechtzeitig; Im Wellenlötverfahren, Verwenden Sie häufig einen wasserhaltigen Flussmittelwiderstand, wenn die Vorheiztemperatur der Leiterplatte nicht ausreicht, Der Wasserdampf im Flussmittel dringt entlang der Lochwand des Durchgangslochs in das Innere des PCB-Substrats ein, und der Wasserdampf um das Pad herum dringt zuerst ein, und in diesen Situationen entstehen Blasen, wenn hohe Schweißtemperaturen auftreten.
Die Lösung ist: (1) Alle Aspekte sollten streng kontrolliert werden, Die gekaufte Leiterplatte sollte nach der Lagerung überprüft werden, normalerweise unter normalen Umständen, Es sollte kein Blasenphänomen geben.
(2) PCB sollte in einer belüfteten und trockenen Umgebung gelagert werden, Die Speicherdauer beträgt nicht mehr als 6 Monate; (3) Die Leiterplatte sollte vor dem Schweißen bei 105 °C/4 bis 6 Stunden im Ofen vorgebacken werden;
